您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2021-02-16 08:33
电子微组装封装技术,是用于电子元器件、电子微组装组件(HIC、MCM、SiP等)内部电互连和外部保护性封装的重要技术,它不仅关系到电子元器件、电子微组装组件自身的性能和可靠性,还影响到应用这些产品的电子设备功能和可靠性,特别是对电子设备小型化和集成化设计有着重要影响。
在电子器件的生产中,电子产品体积的70%~99%由封装手段决定;封装成本占产品成本的30%~80%;超过50%的产品失效与封装有关;60%以上的热阻源于封装;50%以上的信号延迟源于封装;电子器件50%以上的电阻源于封装。
一、定义
美国乔治亚理工学院的Rao R. Tummala等在“微电子封装手册”中将微电子封装定义为:将一定功能的集成电路芯片,放置到一个与之相应的外壳容器中,为芯片提供一个稳定可靠的工作环境;同时,封装也是芯片各个输入端、输出端与外界的过渡手段,并且能有效地将封装内元器件工作时所产生的热量向外扩散,从而形成一个完整的整体,并通过一系列的性能测试、筛选和各种环境、气候、机械试验,来确保元器件的质量,使之具有稳定、正常的功能
二、功能
电子微组装封装技术,包括电子微组装技术和组件封装技术。其中,电子微组装技术指组件内部元器件、基板安装的微组装技术和实现局部微区电互连的微互连技术,如芯片焊料焊接或烧结、元件有机胶黏结等微组装,丝键合、基板互连通孔、硅基板TSV等电连接的微互连;组件封装技术指组件外部保护性封装技术,如模塑封装、陶瓷气密封装、金属气密封装等。
电子微组装封装技术是在电子器件传统封装技术上发展起来的,也称微电子封装技术,它不仅包含传统的封装技术,更拓展了高密度组装和封装技术。在微组装组件中单片集成电路、IC芯片功能的实现,要靠连接引出信号,即靠封装组成半导体器件,因此,封装不仅是IC支撑、保护的必要条件,也是其功能实现的组成部分,没有封装的芯片无法正常工作。采用电子微组装封装技术的电子微组装组件,其组装和封装应具备以下四种功能[3]。
(1)电源分配。微组装组件的封装结构首先为芯片接通电源,使电流流通。其次,根据组件内部器件不同部位所需电源不同的原理,能合理地为不同部位提供合理的电源分配,包括地线的分配问题,以减少电源的不必要损耗,这在组件的多层布线基板上尤为重要。
(2)信号分配。为尽可能减小电信号的延迟,在布线时要尽可能使信号线与芯片的互连路径及通过封装的I/O引出路径达到最短。对于高频信号,还要考虑信号间的串扰,以进行合理的信号分配布线和接地线分配。
(3)散热通道。各种微电子封装都要考虑器件、部件长期工作时如何将聚集的热量散出的问题。不同的微组装封装结构和材料具有不同的散热效果,对于大功耗的微电子封装,还要考虑附加热沉或使用强迫风冷、水冷的方式,以保证系统在使用温度要求范围内正常工作。
(4)机械支撑和环境保护。微组装组件的组装封装结构为器件芯片和其他元件提供可靠的机械支撑,并且能够适应热、机械、潮湿等环境及环境应力的变化。微组装组件在试验和使用过程中,各种环境因素可能为半导体器件的稳定性、可靠性带来很大影响,所以微组装和封装结构还应为内部芯片和元件提供可靠的环境保护功能。
三、分级
根据电子行业的定义,微电子封装依照制作工艺、流程和系统结构的不同,可以分为四个不同层次的分级,典型的微电子封装分级如图1所示。
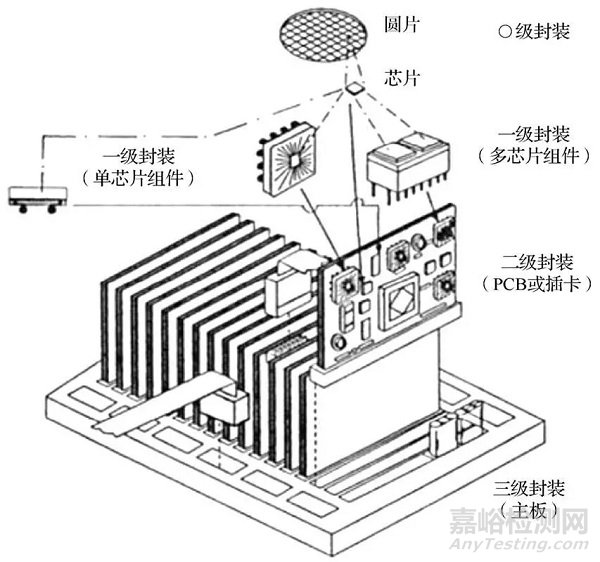
图1 典型的微电子封装分级
由图1可知,〇级封装被定义为在圆片上的制作过程,如IC制造、倒装芯片(Flip Chip)的凸点形成等;也有将〇级封装泛指未加封装的裸芯片,芯片由半导体厂商提供,分两大类,一类是标准系列化芯片,另一类是针对系统用户特殊要求的专用芯片。
一级微封装又称为芯片级封装(简称一级封装),即采用微组装微互连技术和外壳封装技术将单芯片或多芯片封装在一个包封和气密封装腔体内,是目前微电子封装的主体。一级封装着重于将单个器件或多个元器件封装起来,而所涉及的封装形式则有很多,其封装类型如图2所示。一般来说,常根据芯片数量把一级封装简单分为单芯片封装和多芯片封装两大类。前者是对单个裸芯片进行封装;后者则是将多个裸芯片或尺寸封装芯片搭载于多层基板上进行封装。一级封装的典型产品:分立电子器件、混合集成电路、多芯片组件和SiP组件。

图2 一级微电子封装的分类
二级微电子封装又称板级封装(简称二级封装),即采用表面贴装技术(Surface Mount Techology, SMT)等技术将带封装的分立元器件组装到基板上(PCB或其他布线基板)。二级封装以SMT为主体,通过一系列构成板卡的装配工序,将多个完成一级封装的单芯片封装或多芯片组件,安装在PCB等多层基板上,也有将裸芯片直接安装在PCB上形成的组件,基板周边设有插接端子,用于与母板及其他板卡的电气连接。常见的计算机主板生产就属于二级封装的范畴。二级封装的典型产品:混合微电路或多芯片模块。
三级微电子封装又称单元组装,即采用插卡或插座技术将多个二级封装的板卡通过插接端子,搭载在称为母板的大型PCB上,构成单元组件,形成密度更高、功能更多、更复杂的三维立体封装单元产品。传统的三级封装的典型产品:柜式组件单元和印制线路组件(Printed Wire Assembly, PWA)。
由于导线和导电带与芯片间键合焊接技术的大量应用,一级、二级封装技术之间的界限已经模糊了。国内基本上把〇级和一级封装形式称为封装,一般在元器件研制和生产单位完成。把相对应国际统称的二级和三级封装形式称为电子组装。微电子封装不但直接影响着电路本身的电性能、机械性能、光性能和热性能,还在很大程度上决定着电子整机系统的小型化、多功能化、可靠性和成本。

来源:可靠性杂坛


