Silicon Based Epitaxial Thin Films
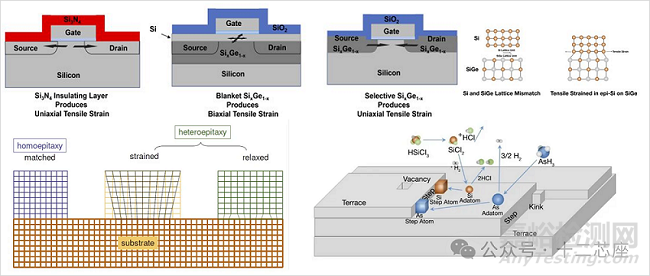
什么是外延工艺
外延被定义为“一种晶体物质在另一种晶体物质上的规则取向生长”。同质外延(在与衬底相同材料上生长外延层)和异质外延(在与衬底不同的材料上生长外延层)这两种工艺都用于半导体器件制造。根据界面条件和晶格参数,异质外延膜可以形成应变或弛豫的晶格结构。
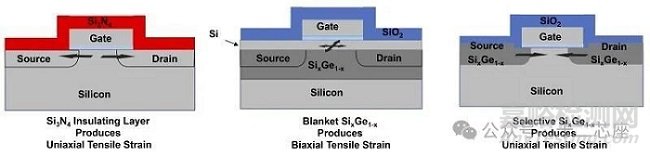
膜中的应变可以是双轴的或单轴的,这取决于不同材料在器件中的排列方式。
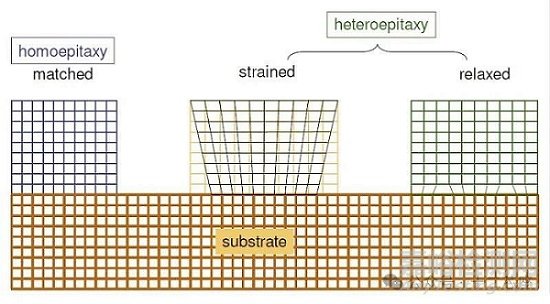
外延膜可以通过多种不同的方法形成,包括蒸发、溅射、分子束外延、液相外延和化学气相外延。
关键要点
外延工艺可以在同种材料的衬底上生长出更高纯度的层。在外延过程中,生长的方向由底层晶体决定。外延工艺影响器件的质量、特性、电学性能等。
目标
在外延工艺中,目标是使电子通过器件的传输更加有效。在外延工艺中,目标是使电子通过器件的传输更加有效。在半导体器件的构建中,外延层被包含在内,以细化并使结构均匀化。
工艺
外延工艺允许在同种材料的衬底上生长出更高纯度的层。在某些半导体材料中,如HBT或MOSFET,外延工艺被用于生长与衬底不同的材料层。正是外延工艺使得在高掺杂材料层上生长低掺杂密度层成为可能。
外延影响因素
1.影响因素
温度:影响外延生长速率和外延层密度。外延工艺所需的温度高于室温,具体值取决于外延类型。
压力:影响外延生长速率和外延层密度。
缺陷:外延中的缺陷会导致晶圆出现故障。为了实现无缺陷的外延层生长,应维持外延工艺所需的物理条件。
期望位置:外延生长应在晶体的正确位置上进行。应适当覆盖那些需要排除在外延工艺之外的区域,以防止生长。
自掺杂:由于外延工艺在高温下进行,掺杂原子可能会导致材料发生变化。
外延生长的密度是指在外延生长层中单位体积内材料的原子数量。温度、压力和半导体衬底的类型等因素会影响外延生长。通常,外延层的密度会随着上述因素的变化而变化。外延层生长的速度称为外延生长速率。
如果外延生长的位置和方向正确,生长速率会较高,反之则较低。与外延层密度类似,外延生长速率也依赖于温度、压力和衬底材料类型等物理因素。外延生长速率在高温和低压下会增加。外延生长速率还取决于衬底结构的方向、反应物的浓度以及所采用的生长技术。
SiGe epi
用于生产未掺杂和掺杂外延硅和Si1-xGex的化学反应包括:
SiCl4 + 2H2 → Si + 4HCl (~1200°C)
SiHCl3 + H2 → Si + 3HCl (~1150°C)
SiH2Cl2 → Si + 2HCl (~1100°C)
SiH4 → Si + 2H2 (~1050°C)
GeH4 → Ge + 2H2
B2H6 → 2B + 3H2
PH3 → P + 3/2H2
AsH3 → As + 3/2H2
外延工艺方法
外延工艺有多种方法:液相外延、混合气相外延、固相外延、原子层沉积、化学气相沉积、分子束外延等。
两种外延工艺对比:CVD vs MBE1
1.化学气相沉积(CVD)
化学工艺
当气态前驱体在生长室或反应器中遇到加热的衬底时会发生化学反应
对薄膜生长过程有精确控制
在需要高质量外延层的应用中被广泛使用
是最常用的方法
半导体制造中的外延工艺至关重要,它优化了半导体器件和集成电路的性能。这是影响器件质量、特性及电学性能的主要工艺之一。
2.分子束外延(MBE)
物理工艺
在真空条件下加热待沉积的材料
对生长层厚度和成分有精确控制
在需要极精细外延层的应用中被广泛使用
成本较高