您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2022-03-01 22:24
本文通过对BGA芯片枕头缺陷的形成机理进行分析,并运用鱼骨图分析造成枕头缺陷的主要原因,提出可行性对策。最后通过实例的形式使用高活性焊锡膏,优化钢网开孔和回流焊接曲线等方面进行工艺改善,有效改善了BGA枕头缺陷。
1、枕头缺陷定义
枕头缺陷(Head-in-Pillow,简称 HIP)是常见于球状引脚栅格阵列封装(BGA)、芯片级封装(CSP)组件的一种失效。枕头现象是 BGA、CSP 元件的锡球没有和焊锡充分的融合,从而未能形成良好的电气连接和机械焊点。从切片分析看,锡膏与 BGA 锡球经过回流但没有结合在一起,就像头被安置在一个柔软的枕头中,通常称为枕头缺陷。枕头缺陷切片如图1所示。
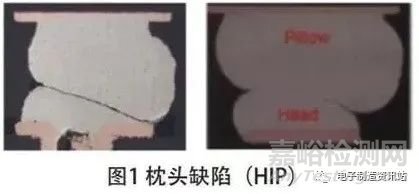
2、枕头缺陷的危害
虚焊有很大的隐蔽性,往往能通过功能测试,但由于焊接强度不够在后续的测试、装配、运输或使用过程中有可能会发生失效,对产品质量和公司信誉都将造成很大的影响。因此枕头缺陷危害性极大。
3、枕头缺陷的检测方法
3.1 、切片分析法
切片分析比较直观,在电子显微镜下能够明显的观察到上下焊点没有熔融在一起,存在缝隙,见图 2。

3.2 、剥离分析法
此方法是把故障芯片从 PCBA 上剥离开来,在显微镜下观察锡球周边比较圆润,类似“球窝”,且没有明显的撕裂,见图 3。
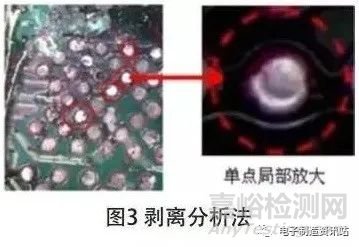
3.3、X-RAY 分析法
2D X-RAY 旋转 45 度后,观察焊点有拖尾的现象,呈现葫芦状连接,见图 4 红色箭头处。
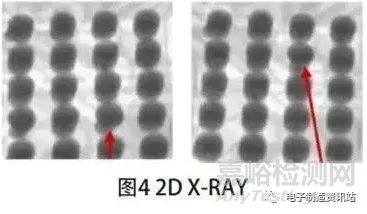
3D X-RAY 会更加直观,见图 5。
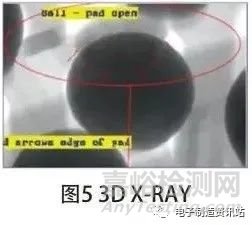
3.4、 侧面观察法
可以利用立体显微镜对 PCBA 进行直接观察,检查焊点是否有枕头现象。缺点是只能观察 BGA 外围的焊点,对于细间距 BGA 观察困难。
4、枕头缺陷形成机理
业界对 HIP 的发生机理有一定的争议,一般认为由于 BGA 封装翘曲、焊球氧化或污染、焊锡膏除氧化能力不足、锡膏印刷和贴装偏移等因素,在回流焊接的加热过程中,部分焊球与锡膏产生分离。
当 BGA 封装因为进一步加热而变平整时,虽然焊锡球与熔融的锡膏重新接触,但是焊球面新形成的氧化层(SnO、SnO2)阻止了焊球和锡膏的进一步结合。于是便形成类似一颗头靠在枕头上的虚焊或假焊的焊接形状,见图 6。

5、枕头缺陷要因分析
运用头脑风暴法,借助鱼骨图,从“人、机、料、法、环”等方面分析造成 BGA 枕头虚焊的原因,见图 7。

能够造成 HIP 缺陷的原因很多,从鱼骨图可以分析出主要影响因素有部品翘曲,焊球表面异常,助焊剂耐热性不足,印刷少锡(锡量不足),锡膏润湿力不足,预热温度过高、时间长等(见上图中“☆”号部分),后续围绕主要问题进行分析。
5.1、 部品翘曲
元器件的封装设计、材质都可能造成器件的翘曲。BGA 封装的载板耐温不足时也容易在回流焊的时候发生载板翘曲变形问题,进而形成枕头缺陷,见图 8。

可行性对策 :通过更换物料,避免受潮,降低炉温请措施减少元件变形量。
5.2 、焊球表面异常(污染或氧化)
BGA 在 IC 封装厂完成后都会使用探针来接触焊球做功能测试,如果探针的洁净度没有处理的很好,有机会将污染物沾于 BGA 的焊球而形成焊接不良。
其次,如果 BGA 封装未被妥善存放于温湿度管控的环境内,也可能会造成本体受潮、焊球氧化。BGA 封装厂植球时一般使用水溶性助焊剂,清洗不足时会造成残渣附着在焊球的表面,容易腐蚀锡球。见图 9。
可行性对策 :生产管控。

5.3、锡膏印刷不良
印刷于焊盘上面的锡膏量多寡不一就会造成锡膏无法接触到焊球的可能性,并形成枕头缺陷。另外,如果 PCB 定位不良或印刷参数设置不当,锡膏印刷偏离电路板的焊盘太远、错位,通常发生在多拼板的时候,当锡膏熔融时将无法提供足够的焊锡形成连接,就会有机会造成枕头缺陷。见图 10。
可行性对策 :生产管控,减少偏移。
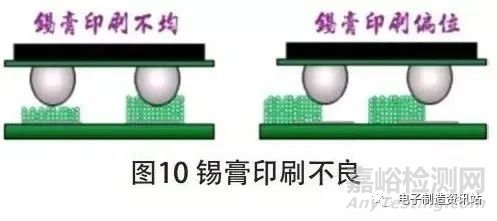
5.4、钢网设计
在工艺问题中,钢网设计可能是最重要的。不良的钢网开孔会导致锡膏沉积不足,这会造成 BGA 跟锡膏接触不良,或者没有足够的助焊剂来消除焊球表面的氧化物。面积比以及脱模率是两个主要影响因素,低的脱模率会降低焊盘上的总的锡膏沉积量,可能导致助焊剂的润湿不足,并因此造成枕头缺陷的发生。
可行性对策 :对于枕头虚焊,增加钢网厚度是最好的选择,但因周边元件影响不能增加钢网厚度时可以考虑增加开孔面积,增加焊锡量,同步增多了助焊剂。
5.5、锡膏
锡膏中助焊剂的作用过程可以分三个部分 :活化、抗氧化性及延长钢网 / 粘性寿命。高活性是助焊剂中的有用部分,可以去除焊球及焊料中的氧化物 ;抗氧化性,例如助焊剂中高含量的松香,是很有效的,可以防止合金形成新的氧化物,这意味着将有更大的活性来防止器件的氧化。
此外,由于锡膏配方的原因提高抗氧化性的同时也增加了粘性,这对于防止枕头缺陷的产生是非常有帮助的。如果焊膏一直维持着粘性,即使器件翘曲,焊膏也会延伸并保持连续性,因而在回流时焊膏和器件会始终维持一个整体并形成单一合金。
可行性对策 :锡膏助焊剂耐热性不足和润湿力不佳是造成的焊接枕头缺陷的主要问题,提高锡膏中助焊剂的抗高温性和防氧化性对防止枕头缺陷的产生非常重要。
5.6、回流焊接曲线
当回流焊的温度或升温速度没有设好时,就容易发生没有融锡或 BGA 翘曲问题。长时间的高温使锡膏活性在回流焊接时基本上消耗殆尽,此时 BGA 锡球表面与焊锡的接触过程中已经失去了助焊剂的保护并且没有熔进锡膏主体,从而形成 HIP。
可行性对策:条件允许的情况下,在设置标准范围内减少预热时间,降低焊接温度。
6、案例:主芯片枕头缺陷原因分析及改善
某公司通信产品发现存在约 1% 左右不开机,分析是主芯片M***** 虚焊,经过剥离发现是主芯片枕头缺陷,不良焊点较多,见图 11。后面我们主要考虑从部品、工艺方面进行分析和改善。
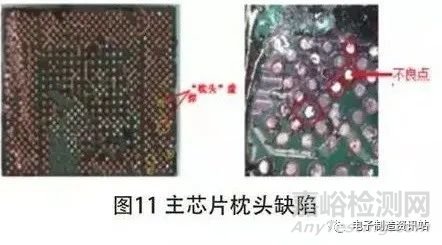
6.1、BGA 翘曲和焊球氧化测试
通过调查,发现芯片供方有二个封装厂 :TW 封装厂和 SH 封装厂。TW 封装厂的芯片虚焊不良率为 3% 左右,SH 封装厂的芯片虚焊不良率为 0。将二个封装厂的芯片各取样 10pcs 送第三方实验室检测,测试数据如图 12、表 1。
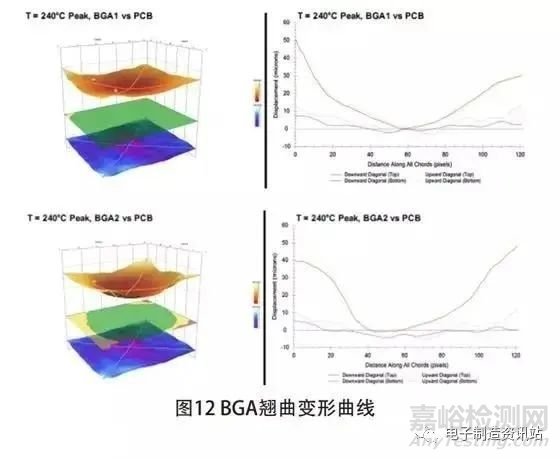
测试结果分析:芯片变形距离不大,均符合小于 80um 的要求。190-240 度区间,TW 封装厂的芯片比 SH 封装厂的芯片高温形变大。测量芯片焊锡球,未发现氧化以及污染的现象。

6.2、回流焊接曲线调整
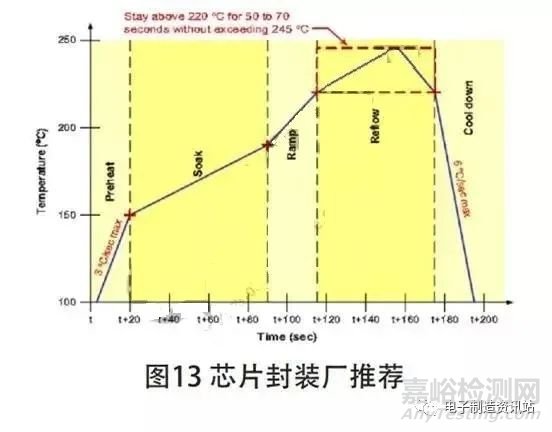

图13 是封装厂家推荐的回流焊接曲线,图14 是锡膏厂家推荐回流焊接曲线,根据推荐曲线将实际回流炉进行优化,适当减少预热时间,减低峰值温度。减少保温时间不利于排除空洞,温度设置一定要兼顾。优化后的参数设置及实际测量数据见表 2 和图 15。


优化后实际测量曲线符合表 2 的要求。
采用优化后的回流焊接温度曲,跟踪生产状态,TW 封装厂芯片焊接不良率还是 3% 左右,无明显改善。
6.3、增加焊锡量
目前主芯片钢网开孔为直径 0.26mm 圆(钢网厚度 0.1mm),将钢网开孔增大至 0.25mm 方孔进行验证。0.25mm 方形开孔理论印刷锡膏面积比 0.26mm 圆形大,有利于增加焊锡量,面积比(AR)二者比较接近,焊锡实际体积增加13.6%。见表 3。
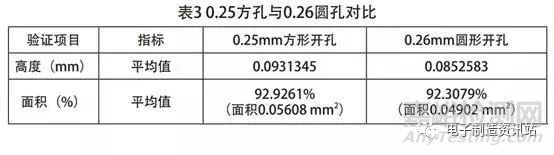
0.25mm 方形开孔体积 :0.05608*0.0931345 mm30.26mm 圆孔开孔体积 :0.04902*0.0852583 mm30.25mm 方形开孔(倒圆角)试验结果:锡膏体积增加 24.97%。使用 0.25mm 方形开孔的钢网,连续跟踪生产 10k,TW 封装厂的芯片虚焊率 2.7%,稍有改善但不明显。
6.4、锡膏抗氧化不足
目前我们使用的锡膏型号是 S 品牌 M**,其成分 Sn-1.0Ag-0.7Cu-Bi-In,类型 Type4。本锡膏主要特点是在降低 Ag 含量的同时,增加了 Bi 和 In 元素,成本上比较有优势。M** 的助焊剂型号为LS720,在现在的锡膏中抗氧化性一般,更换成分为 SAC305 抗氧化性比较强的 S*** 进行验证。
验证结果如下:使用同批次的 TW 封装厂供应的 M***** 芯片,批次号 E1517。M** 与 S*** 锡膏各生产 1000pcs 对比,见表 4。

实验结果分析 :使用 M* * 锡膏,CPU 虚焊率 3%。使用 S*** 锡膏,CPU 虚焊率 0%。S*** 锡膏对改善 TW 封装厂芯片虚焊效果较好。
6.5、其他
还有一些其他的方法增加抗氧化性及活性,如氮气回流,增加助焊剂,焊膏浸蘸工艺等。氮气回流不会去除器件上已有的氧化物和氢氧化物,但可以预防在回流过程中增加氧化物的形成。助焊剂或焊膏浸蘸是可行的选择,因为这直接在器件上增加了活性物质,而不是等着板子上的助焊剂来去除。但这种操作增加了焊接工艺和生产成本,不能长期有效实施,在有其他改善措施的情况下不建议采用。
7、结束语
BGA 枕头缺陷一般是由多种影响因素综合作用形成的,在分析和解决问题的时候,要抓住主要影响因素。本案例中主芯片虚焊通过分析以及验证实验,初步形成以下结论 :
(1)M***** 虚焊为枕头缺陷(HIP)。
(2)测试芯片高温形变均没有超出 80um,但 TW 封装厂的芯片高温形变比 SH 封装厂的芯片大。芯片测量20pcs 未发现锡球异物。
(3)S*** 焊锡膏焊抗枕头缺陷能力比目前使用的 M** 好,能够较好的解决 TW 封装厂芯片的 HIP 虚焊。对于 HIP 的解决,更换抗氧化性较高的锡膏是最好的选择。
(4)调整炉温曲线对解决芯片枕头缺陷改善效果不明显。
(5)增加焊锡量对于 HIP 稍有改善,适当增加钢网厚度可以抑制枕头焊点的发生。
(6)条件允许建议增加氮气焊接,减少锡球氧化几率。

来源:SMT技术网


