您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2021-11-04 20:57
塑料封装失效机理
封装分层并长期暴露于潮湿环境
器件受热,封装内水汽膨胀;
机械应力引起芯片形变和压焊点脱落;
漏电流变化或开路。
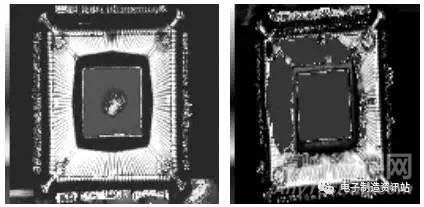
例:爆米花效应引起塑封器件内引线开路

例:包封料-键合点分层引起塑封器件内引线开路
纠正措施
装配前塑封器件不能长时暴露于潮湿空气;
塑封器件长时暴露于潮湿空气,装配前要烘干;
控制封装工艺,避免塑封器件分层;
控制电路板焊接工艺,防止塑封器件长时间过热。
引线键合失效的机理
半导体器件的铝电极与管脚用内引线连接,内引线可分为金线和铝线两种。金-铝键合失效主要表现是:金内引线与芯片上的铝层压焊点发生固相反应,形成称为紫斑的AuAl2化合物层,导致接触不良或引线脱落。
由于金—铝原子互扩散的扩散系数不同,在金-铝界面还会形成科肯德尔(Kirkendal)空洞,会引起压焊点开路。
引线键合失效的其它原因是键合工艺不良。
引线键合失效的外部原因和分析方法
失效外因:高温试验、振动试验、过电应力、受潮、工艺不良。
失效内因:压焊点金-铝发生化学反应和扩散。
失效分析方法:X射线透视、扫描声学显微镜、打开封装、显微观察、X射线能谱分析。
质检方法:引线拉力测试。
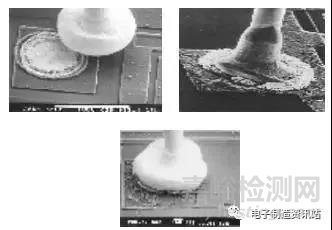
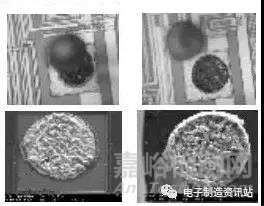
引线键合失效

过电烧毁内引线
纠正措施:
金-铝键合的器件应避免在过高温度下使用和试验。为避免金-铝键合失效,可改用铝硅-铝键合和无线键合。
水汽离子沾污的失效分析方法
芯片表面水汽和离子沾污
芯片表面水汽和离子沾污的失效分析方法:烘烤或开封清洗。
试验结果分析:反向特性可完全恢复为离子沾污和受潮反向特性不可完全恢复为过电或静电。
介质层内部离子沾污
高温储存、高温反偏

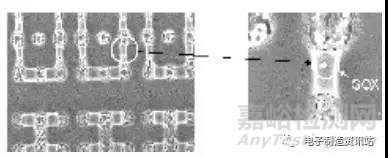
介质失效
EOS损伤的种类和机理
过流(引起过热)
内引线熔断
金属化互连线熔断
Pn结漏电
Pn结穿钉
金属热电迁移过压
氧化层针孔
热电子注入

FPGA电源内引线烧断
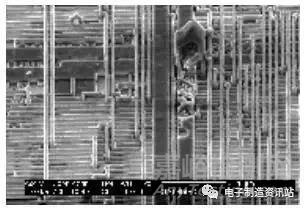
微处理器电源金属互连线烧断
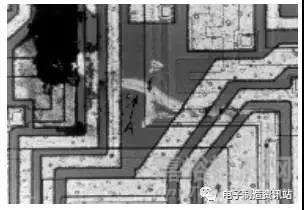
三端稳压器过电烧毁,金属热电迁移
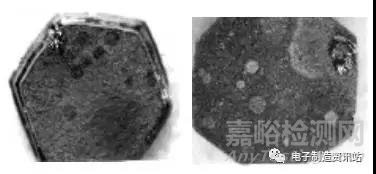
硅整流器RB-156过电烧毁
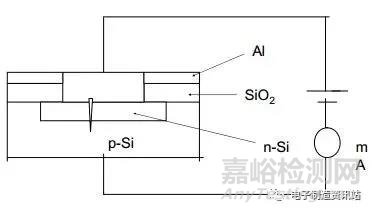
Al-Si互溶

来源:可靠性技术交流


