您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2020-06-05 20:33
一、元器件概述
1、元器件的定义与分类
定义:
欧洲空间局ESA标准中的定义:完成某一电子、电气和机电功能,并由一个或几个部分构成而且一般不能被分解或不会破坏的某个装置。
GJB4027-2000《军用电子元器件破坏性物理分析方法》中的定义:在电子线路或电子设备中执行电气、电子、电磁、机电或光电功能的基本单元,该基本单元可由一个或多个零件组成,通常不破坏是不能将其分解的。
分类:两大类
元件:在工厂生产加工时不改变分子成分的成品,本身不产生电子,对电压、电流无控制和变换作用。
器件:在工厂生产加工时改变了分子结构的成品,本身能产生电子,对电压电流的控制、变换(放大、开关、整流、检波、振荡和调制等),也称电子器件。
分类(来源:2007年版的《军用电子元器件合格产品目录》)

电阻
最可靠的元件之一
失效模式:开路、机械损伤、接点损坏、短路、绝缘击穿、焊接点老化造成的电阻值漂移量超过容差

电位器
失效模式:接触不良、滑动噪声大、开路等

二极管

集成电路
失效模式:漏电或短路,击穿特性劣变,正向压降劣变,开路可高阻
失效机理:电迁移,热载流子效应,与时间相关的介质击穿(TDDB),表面氧化层缺陷,绝缘层缺陷,外延层缺陷
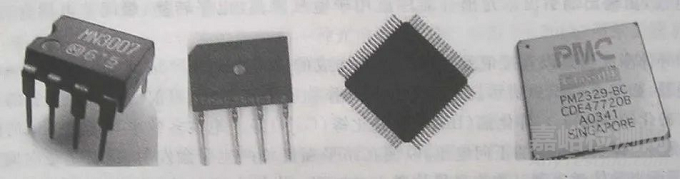
声表面波器件
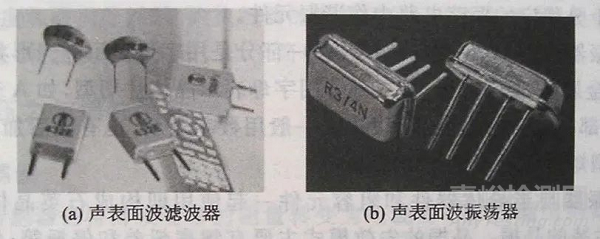

MEMS压力传感器
MEMS器件的主要失效机理: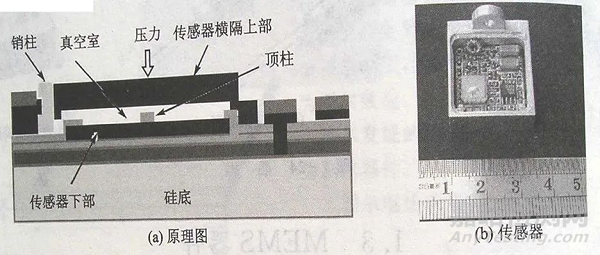
(1)粘附----两个光滑表面相接触时,在力作用下粘附在一起的现象;
(2)蠕变----机械应力作用下原子缓慢运动的现象;变形、空洞;
(3)微粒污染----阻碍器件的机械运动;
(4)磨损----尺寸超差,碎片卡入;
(5)疲劳断裂----疲劳裂纹扩展失效。
真空电子器件(vacuum electronic device)
指借助电子在真空或者气体中与电磁场发生相互作用,将一种形式电磁能量转换为另一种形式电磁能量的器件。具有真空密封管壳和若干电极,管内抽成真空,残余气体压力为10-4~10-8帕。有些在抽出管内气体后,再充入所需成分和压强的气体。广泛用于广播、通信、电视、雷达、导航、自动控制、电子对抗、计算机终端显示、医学诊断治疗等领域。
真空电子器件按其功能分为:
实现直流电能和电磁振荡能量之间转换的静电控制电子管;
将直流能量转换成频率为300兆赫~3000吉赫电磁振荡能量的微波电子管;
利用聚焦电子束实现光、电信号的记录、存储、转换和显示的电子束管;
利用光电子发射现象实现光电转换的光电管;
产生X射线的X射线管;
管内充有气体并产生气体放电的充气管;
以真空和气体中粒子受激辐射为工作机理,将电磁波加以放大的真空量子电子器件等。
自20世纪60年代以后,很多真空电子器件已逐步为固态电子器件所取代,但在高频率、大功率领域,真空电子器件仍然具有相当生命力,而电子束管和光电管仍将广泛应用并有所发展。[1] 真空电子器件里面就包含真空断路器,真空断路器具有很多优点,所以在变电站上应用很多。真空断路器已被快易优收录,由于采用了特殊的真空元件,随着近年来制造水平的提高,灭弧室部分的故障明显降低。真空灭弧室无需检修处理,当其损坏时,只能采取更换。真空断路器运行中发生的故障以操作机构部分所占比重较大,其次为一次导电部分,触头导电杆等。
第二章 元器件制造工艺与缺陷
1、芯片加工中的缺陷与成品率预测
芯片制造缺陷的分类:
全局缺陷:光刻对准误差、工艺参数随机起伏、线宽变化等;在成熟、可控性良好的工艺线上,可减少到极少,甚至几乎可以消除。
局域缺陷:氧化物针孔等点缺陷,不可完全消除,损失的成品率更高。
点缺陷:冗余物、丢失物、氧化物针孔、结泄漏
来源:灰尘微粒、硅片与设备的接触、化学试剂中的杂质颗粒。
2、混合集成电路的失效
混合集成电路工艺:
IC工艺:氧化、扩散、镀膜、光刻等
厚膜工艺:基板加工、制版、丝网印刷、烧结、激光调阻、分离元器件组装等
薄膜工艺:基板加工、制版、薄膜制备、光刻、电镀等
失效原因:
元器件失效:31%
互连失效:23%,引线键合失效、芯片粘结不良等
沾污失效:21%
关于混合集成电路:
按制作工艺,可将集成电路分为:
(1)半导体集成电路(基片:半导体)
即:单片集成电路(固体电路)
工艺:半导体工艺(扩散、氧化、外延等)
(2)膜集成电路(基片:玻璃、陶瓷等绝缘体)
工艺:
薄膜集成电路——真空蒸镀、溅射、化学气相沉积技术
厚膜集成电路——浆料喷涂在基片上、经烧结而成(丝网印刷技术)
3、混合集成电路(Hybrid Integrated Circuit)
特点:充分利用半导体集成电路和膜集成电路各自的优点,达到优势互补的目的;
工艺:用膜工艺制作无源元件,用半导体IC或晶体管制作有源器件。
三种集成电路的比较:
第三章 微电子封装技术与失效
1、微电子封装的分级:
• 零级封装:通过互连技术将芯片焊区与各级封装的焊区连接起来;
• 一级封装(器件级封装):将一个或多个IC芯片用适宜的材料封装起来,并使芯片的焊区与封装的外引脚用引线键合(WB)、载带自动焊(TAB)和倒装焊(FC)连接起来,使之成为有功能的器件或组件,包括单芯片组件SCM和多芯片组件MCM两大类
• 二级封装(板极封装):将一级微电子封装产品和无源元件一同安装到印制板或其他基板上,成为部件或整机。
• 三级封装(系统级封装):将二极封装产品通过选层、互连插座或柔性电路板与母板连接起来,形成三维立体封装,构成完整的整机系统(立体组装技术)
2、微电子的失效机理
(1)热/机械失效

热疲劳
热疲劳失效主要是由于电源的闭合和断开引起热应力循环,造成互连焊点变形,最终产生裂纹
失效分析例子——连接器的过机械应力疲劳损伤
样品:SMA连接器(阴极)
现象:外部插头(阳极)与该SMA接头连接不紧,装机前插拔力检验合格
失效模式:接触不良
半圆弧夹片明显偏离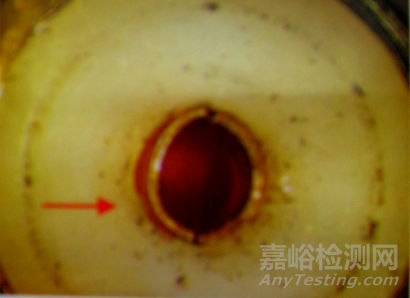
插孔周边绝缘介质有较深的插痕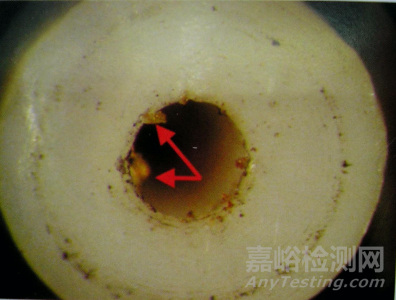
偏离的半圆夹片根部有裂纹
半圆片裂纹断面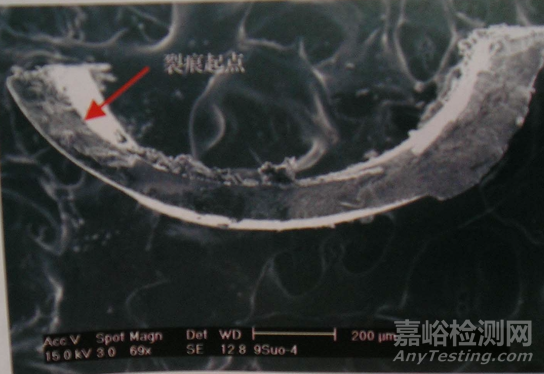
蠕变----材料在长时间恒温、恒压下,即使应力没有达到屈服强度,也会慢慢产生塑性变形的现象
蠕变导致焊点断裂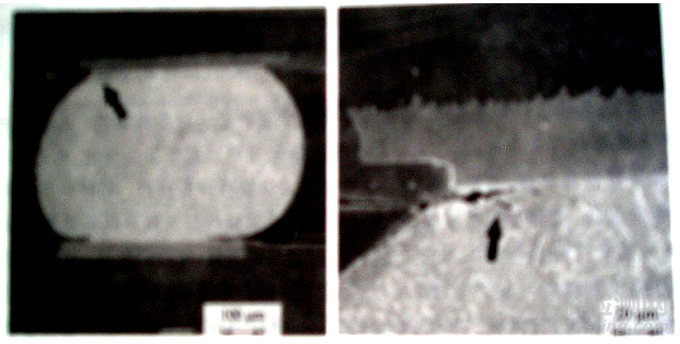
脆性断裂
当应力超过某一值时,陶瓷、玻璃和硅等脆性材料易发生脆性断裂。断裂一般发生在有初始裂纹和刻痕的地方,当原有裂纹扩展到器件的有源区时,器件将失效。
塑性变形
当应力超过材料的弹性限度或屈服点时,将发生塑性变形(永久):
Ø 金属:电阻升高或开裂
Ø 陶瓷等脆性材料:开裂
Ø MEMS系统:影响精度甚至不能正常工作
封装界面层分层----粘连在一起的不同层之间出现剥离或分离的现象
原因:表面缺陷
表面存在水汽和挥发物
材料不均或表面粗糙等
塑封件因热膨胀系数不同,温度变化大时会出现;
塑封件因吸收过多潮气,在受热例如焊接过程中出现分层(爆米花现象);
BGA封装中,模塑料与基体界的界面及粘胶处易发生水汽爆裂。
应力迁移(Stress Migration)
引子:铜互连替代铝互连,虽然铜的电阻率较低,抗电迁移和应力迁移能力强,但应力迁移诱生空洞,导致电阻增大甚至完全断裂
出现条件:应力梯度—绝缘介质与铜之间的热失配所致
位置:通孔和金属连线边缘等应力集中区域
影响因素:应力、应力梯度、互连结构、工作温度、金属介质界面粘附性、互连材料的微观结构
铜导线上的应力迁移空洞
(2)电致失效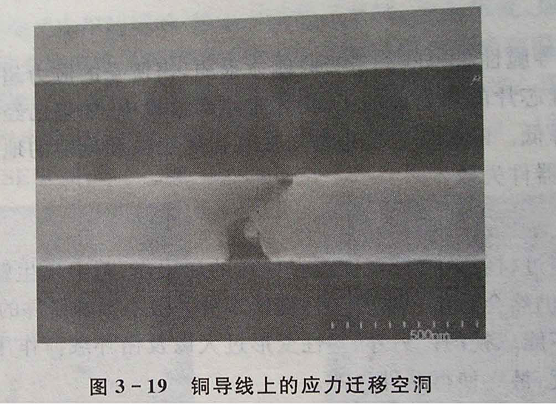
电迁移(Electronic Migration)
强电流经过金属线时,金属离子等会在电流及其他因素相互作用下移动并在线内形成孔隙或裂纹的现象
原因:电场作用下金属离子扩散所致,不同材料机制不同:
焊点:晶格扩散
铝互连线:晶界扩散
铜互连线:表面扩散
驱动力:电子与离子动量交换和外电场产生的综合力、非平衡态离子浓度产生的扩散力、机械应力、热应力
影响因素:
几何因素:长度、线宽、转角、台阶、接触孔等
材料性质:铜最好、铝较差、铝铜合金介于其中
(3)金属迁移
• 失效模式:金属互连线电阻值增大或开路
• 失效机理:电子风效应
• 产生条件:电流密度大于10E5A/cm2
高温
• 纠正措施:高温淀积,增加铝颗粒直径,掺铜,降低工作温度,减少阶梯,铜互连、平面化工艺
互连线和焊点的电迁移
(4)闩锁效应(Latch-up)----寄生PNPN效应
由于MOS管存在寄生晶体管效应(CMOS管下面会构成多个晶体管,它们自身可能构成一个电路),若电路偶然出现使该寄生晶体管开通的条件,则寄生电路会极大影响正常电路的动作,使原MOS电路承受大于正常状态很大的电流,可使电路迅速烧毁。
闩锁状态下器件在电源与地之间形成短路,造成大电流、过电应力和器件损坏
通信接口集成电路的闩锁失效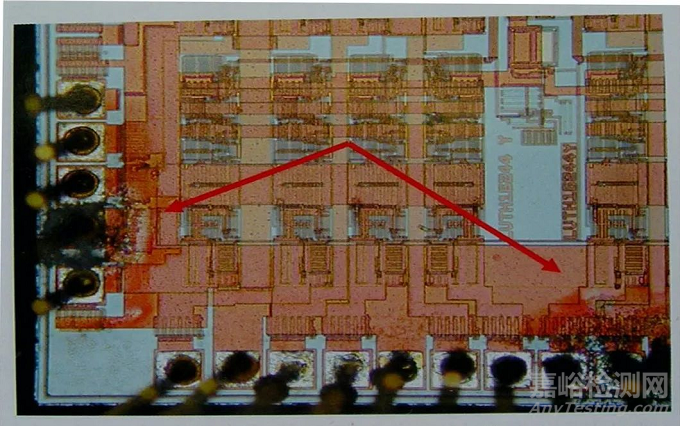
(5)热载流子效应(Hot Carrier Injection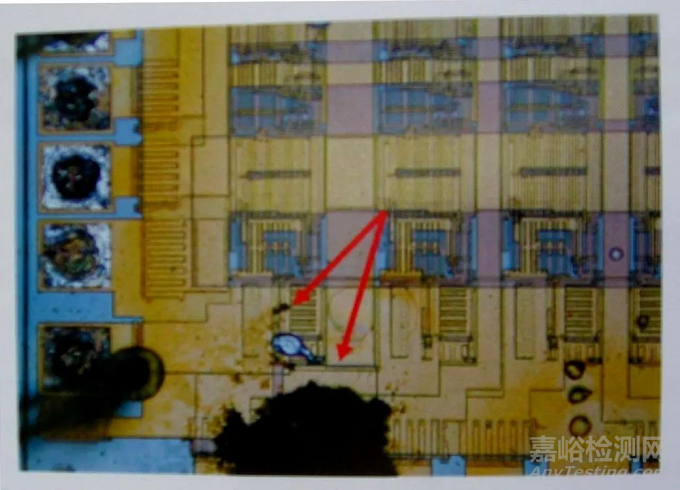
栅极电压Vg小于漏极电压Vd时,栅极绝缘膜下的沟道被夹断,漏极附近电场增高;
源极流经此区的电子成为热电子,碰撞增多---漏极雪崩热载流子;
注入栅极二氧化硅膜中,使其产生陷阱和界面能级,阈值电压增加,氧化层电荷增加或波动不稳,器件性能退化
(6)与时间相关的介质击穿(Time Dependent Dielectric Breakdron)
击穿模型:I/E(空穴击穿),E(热化学击穿)
I/E模型:电子穿越氧化膜®产生电子陷阱和空穴陷阱+电子空穴对®空穴隧穿回氧化层,形成电流®空穴易被陷阱俘获®在氧化层中产生电场®缺陷处局部电流不断增加,形成正反馈®陷阱互相重叠并连成一个导电通道时,氧化层被击穿。
E模型:热动力学过程,处于热应力和外加电场下的偶极子相互作用破坏了Si-O键而产生击穿。
3、电化学失效
• 金属迁移----从键合焊盘处开始的金属枝晶生长,是一金属离子从阳极区向阴极区迁移的电解过程。
现象:桥连区的泄漏电流增加,甚至短路
迁移离子:Ag,Pb,Sn,Au,Cu
预防银迁移的方法:
使用银合金;
在布线布局设计时,避免细间距相邻导体间的电流电位差过高;
设置表面保护层;
清洗助焊剂残留物
• 腐蚀
出现条件:封装内存在潮气和离子沾污物
本质:电化学反应
混合集成电路的电化学腐蚀
• 金属间化合物
• 优点:提高结合力
• 缺点:过量的金属间化合物会使局部脆化

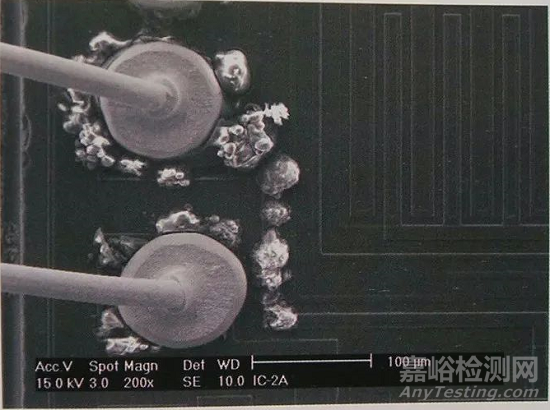

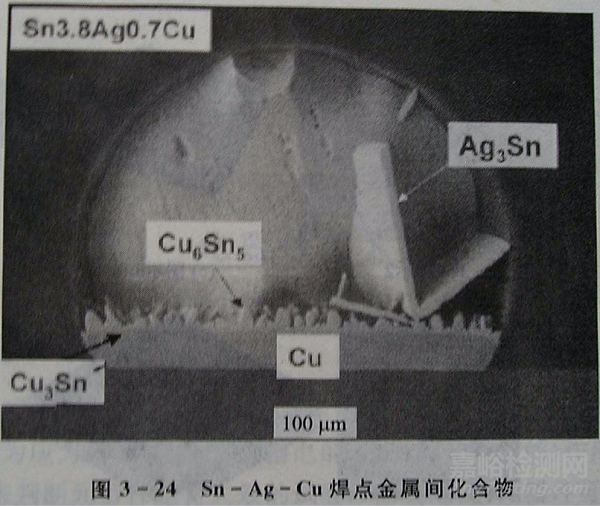

来源:Internet


