您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2022-03-14 23:14
长江存储的XtackingTM是一种新型3D(三维)NAND 闪存架构,其中存储单元和外围电路由数百万对小间距金属通孔进行互联。因此,其键合界面的可靠性引起了人们极大的兴趣。长江存储的Yan Ouyang等人,对XtackingTM键合界面进行了可靠性测试验证。结果表明,经过超长时间的热应力及湿热应力(如7000小时)后,键合界面表现出了稳定的电性能和良好的粘结强度,远高于行业的一般要求(如1000小时)。此外,在长时间温度循环试验后的拉力测试也进一步证明了键合界面具有良好的强度和电气稳定性。
XtackingTM架构的存储单元和外围电路分别是在两个不同的晶圆(晶圆A和B)上制造,然后通过数百万对小间距金属通孔互联。与传统的3D NAND架构相比,XtackingTM架构不仅提高了存储密度,还实现了更高的I/O传输速度。
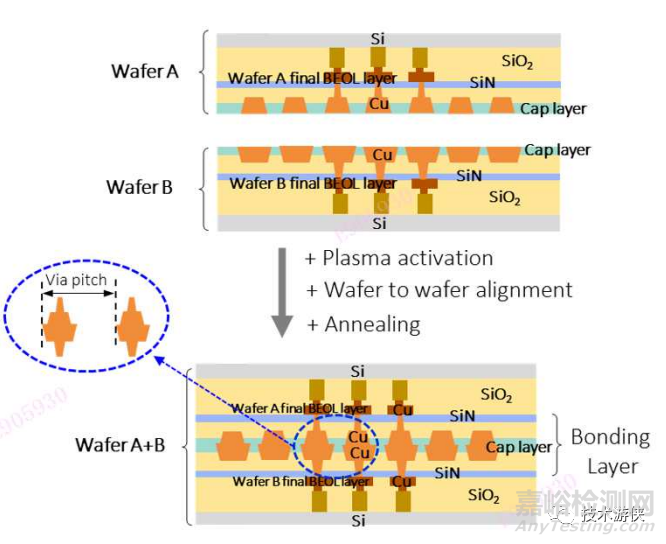
XtackingTM键合工艺的结构示意图
在形成A芯片和B芯片的BEOL layer后,通过电镀和化学机械抛光获得键合通孔,然后通过等离子体清洗、芯片之间对准和退火,这样就可以形成间距约为1μm的键合界面。
键合过程是XtackingTM体系架构中最关键的一步。在键合过程中,数百万对小间距的金属通孔要实现电气互联和保持一定的机械强度。研究人员采用了四种典型键合界面结构,通过监测超长时间热应力或湿热应力下的电阻变化和漏电流,探索了XtackingTM体系架构键合界面的可靠性。
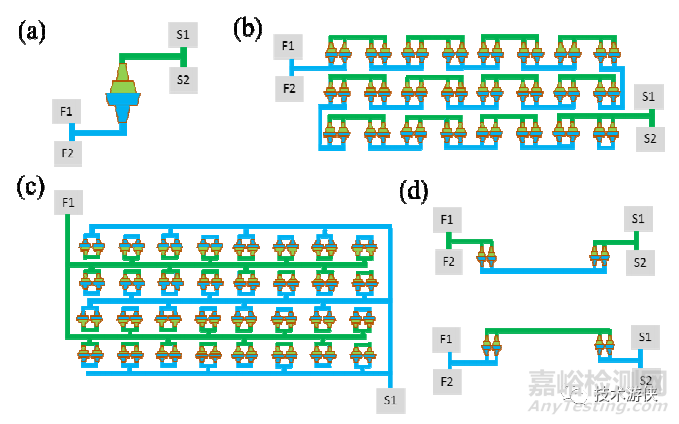
验证键合界面可靠性的试验包括温度循环(TC)、高温贮存(HTS)和稳态湿热(THS),截止条件是电阻值和漏电流超过规定值。从试验条件来看,试验强度还是比较大的,远超产品级的试验条件,THS为7000h、温循为15000次循环、高温贮存为200℃,7000h。

试验结果
(1)温循应力后的变化:a结构和b结构在温循168次、2500次、15000次的阻值变化,以及(c1)在(c2)在15000次后的漏电曲线分布。

(2)高温应力后的变化:a结构和b结构在高温贮存168小时、1000小时、7000小时的阻值变化,以及(c1)在(c2)在7000小时的漏电曲线分布。

(3)稳态湿热应力后的变化:a结构和b结构在稳态湿热168小时、2500小时、15000小时的阻值变化,以及(c1)在(c2)在7000小时的漏电曲线分布。
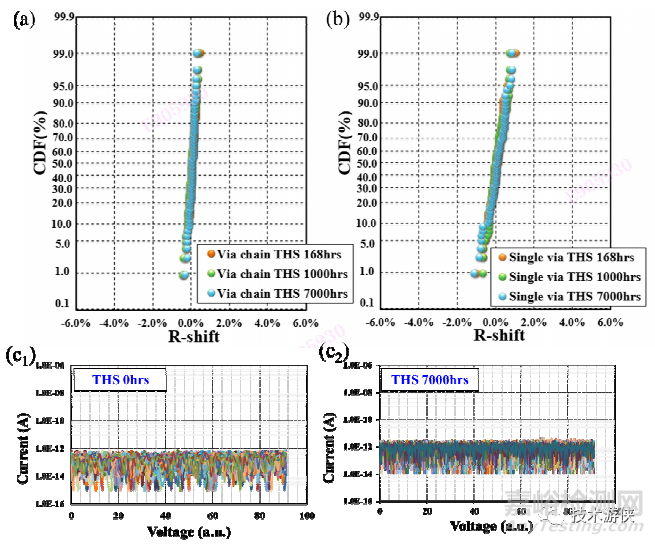
三种可靠性试验后的测试结果显示,键合结构在经过超长时间的温循应力、湿热应力以及高温应力后没有发现明显的电阻值漂移及漏电。

另外,为了进一步分析电阻漂移在三种应力下的变化趋势:在稳态湿热试验中变化较小,而在温循和高温应力下是降低,其中高温应力更为明显,这是由于退火工艺的原因。
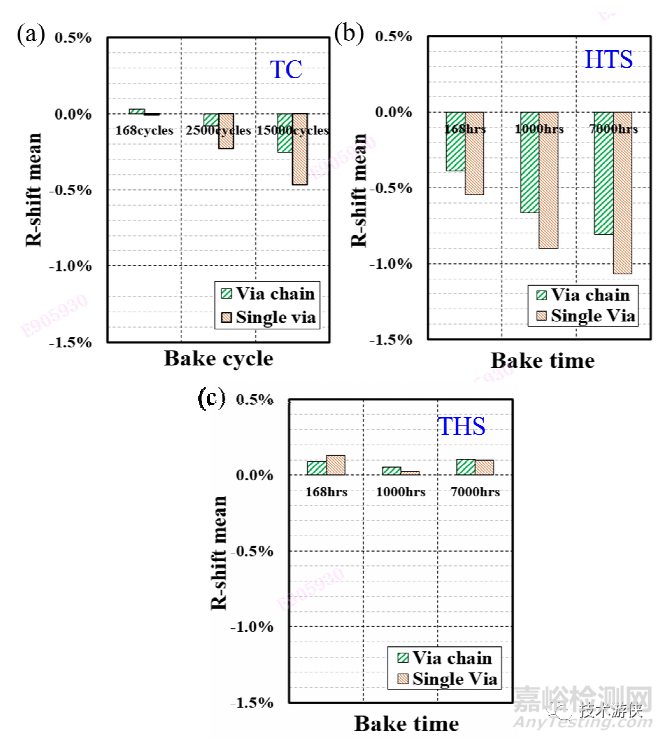
在三种应力后,键合界面没有出现明显裂纹,同时电气性能也非常稳定,这也反映了XtackingTM键合界面良好的可靠性。
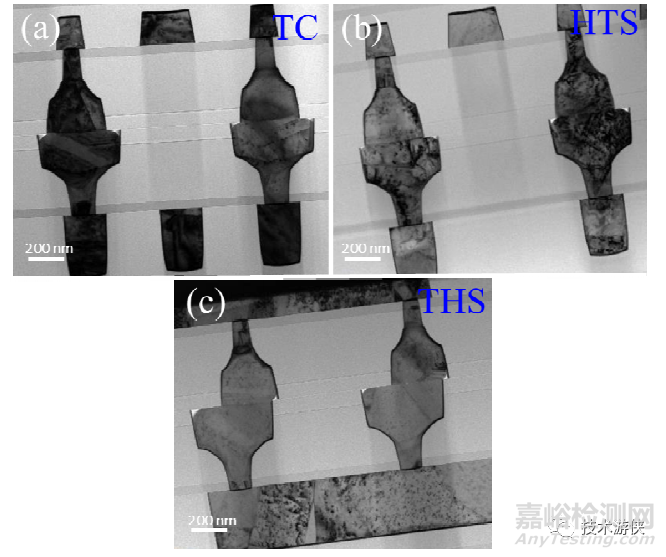
由于温循应力对于可靠性更为敏感,因此进一步验证了键合界面在经历温循后的可靠性。对键合结构施加相对拉力并观察断裂界面形貌,发现键合粘接界面的断裂比例在5%以内,非常小。结果表明,键合界面不是 XtackingTM中最薄弱的层架构,即使经过超长时间温循应力后也不会降低键合界面强度。
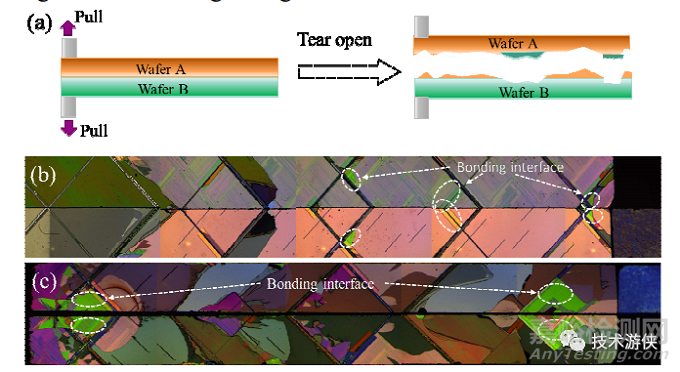
同时,还分析了温循应力对键合通孔附近金属内电介质性能的影响。结果显示,在15000次温循后样品的电压-电流曲线与没有经历温循应力的样品没有明显变化,这意味着在超长时间温循应力后没有更多的铜扩散到键合层电介质或没有损伤,这结果进一步证明了XtackingTM良好的可靠性。
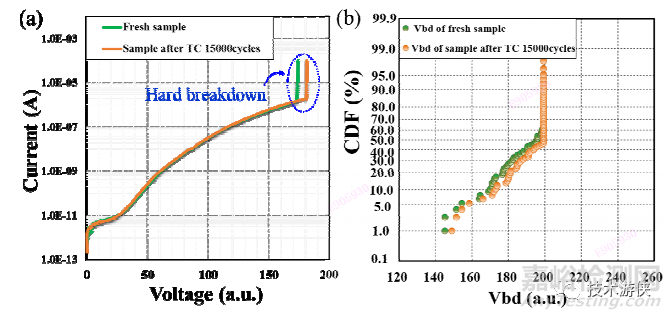

来源:技术游侠


