您当前的位置:检测资讯 > 实验管理
嘉峪检测网 2015-12-31 15:35
1. 案例背景
某功能模块在用户端出现功能失效,经返厂检修,发现该模块上的一片IC输出异常,经更换IC后,功能模块恢复正常。
2.分析方法简述
对样品进行外观观察,未发现明显异常。
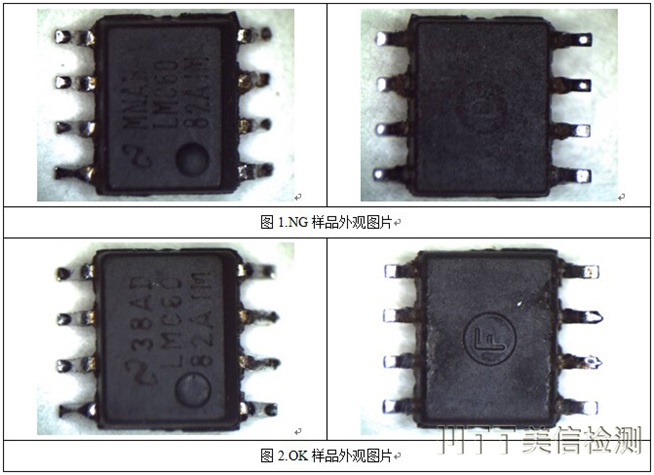
经X-RAY无损检测,未发现明显异常。

通过C-SAM扫描发现了IC内部存在分层现象。
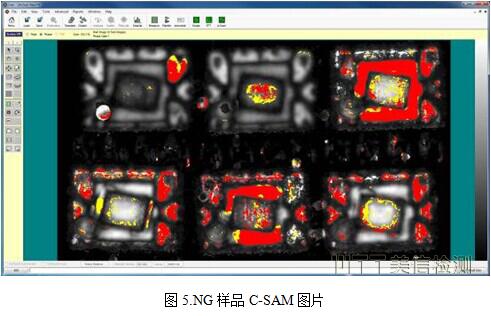
通过IV曲线测试,发现引脚间存在漏电通道。
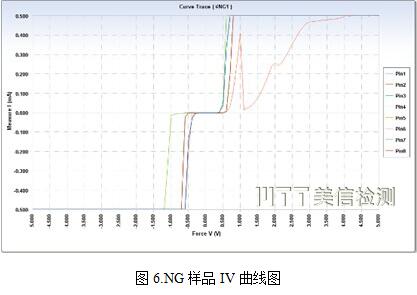
DE-CAP后,利用SEM/EDS进行分析,确认了引脚间存在银迁移问题。
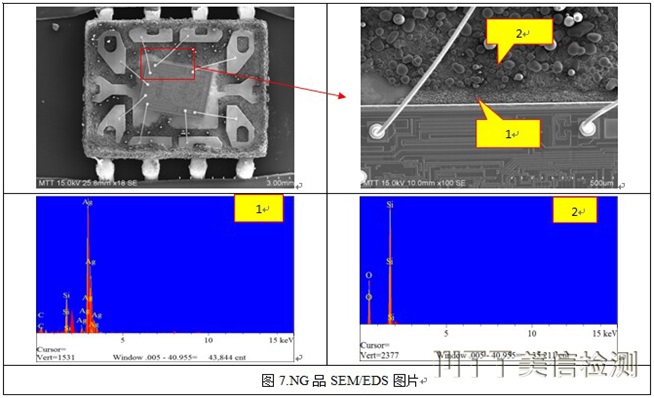

3.结论
IC内部存在分层,由于水汽的入侵,加上集成电路各引脚之间存在电位差,导致了引脚间的银迁移,从而在引脚间形成微导通电路,致IC输出异常。
4. 参考标准
GJB 548B-2005 微电子器件失效分析程序-方法5003。
IPC-TM-650 2.1.1-2004手动微切片法。
GB/T 17359-2012 电子探针和扫描电镜X射线能谱定量分析通则。
来源:深圳市美信检测技术有限


