您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2025-09-13 14:45
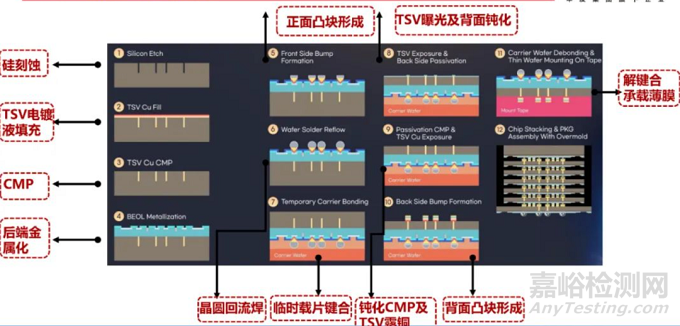

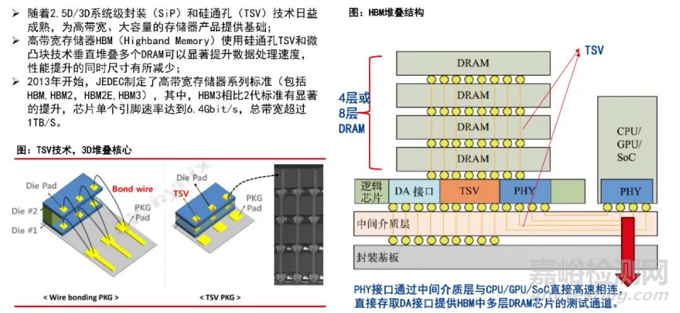

在当今数字化浪潮的澎湃推动下,人工智能、大数据等前沿科技正以前所未有的速度重塑世界。而在这背后,一个关键的技术支撑——HBM(高带宽存储器),正以其卓越的性能,成为高性能计算领域的“幕后英雄”。今天,就让我们深入探索 HBM 的工艺流程与质量管理,一窥其如何为现代科技赋能。
一、HBM 工艺流程:从微观到宏观的精妙构建
(一)TSV 技术:垂直互联的“心脏”
TSV是 HBM 工艺的核心,通过在硅基板中创建垂直的导电通道,实现芯片间的直接连接。这些导电通道的直径通常在 1 - 5um之间,深度可达 10 - 50 um。TSV 的制造流程精细复杂,包括DRIE法行成通孔、绝缘层制备、阻挡层和种子层制备、电镀填充以及抛光等步骤。DRIE 以其出色的制高深宽比孔能力而闻名,可以实现大于 20:1 的深宽比。
具体来说,TSV 孔的形成是通过 DRIE 技术实现的,采用Bosch Process,交替通入 SF₆和 C₄F₈,每周期刻蚀 30 + 钝化 10 s,形成扇贝纹侧壁。刻蚀速率可达 5 - 10μm/min,钝化层厚度为 50 - 100nm。绝缘层沉积则通过PECVD在孔壁覆盖SiO₂绝缘层,厚度为 0.5 - 1μm。阻挡层和种子层的制备通常采用PVD,阻挡层材料为 Ti/TiN,种子层材料为 Cu。
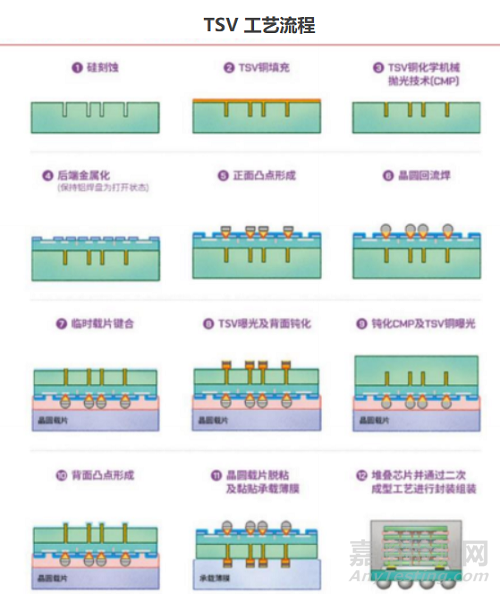
(二)u-Bumping:精准连接的关键
HBM 的 DRAM 芯片之间主要通过 ubump互联,ubump 是电镀形成的铜柱凸点。其制作流程涉及溅射形成UBM、厚涂光刻胶形成掩膜、铜电镀形成凸点,以及通过晶圆级回流焊设备将这些凸点制成球形。微凸点的尺寸通常为 5μm×5μm,间距为 20μm。
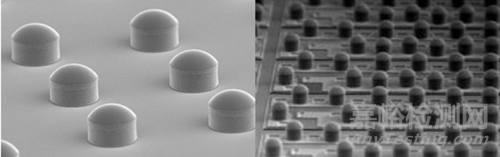
(三)Stacking:技术路径的分化与融合
目前堆栈键合类型主要包括 SK 海力士采用的 MR-MUF 技术、三星电子和美光采用的 TC-NCF技术以及未来有希望用于 HBM4 制造的混合键合技术。TC-NCF 使用非导电薄膜填充微凸点间空隙,再通过热压键合连接两层 die;MR-MUF 则通过回流焊一次性粘合多个芯片,并用模塑料填充间隙。混合键合技术则更为先进,它支持stack die间直接铜 - 铜键合,无需微凸点,提供更紧密的间距、更低电阻和更好的热特性。
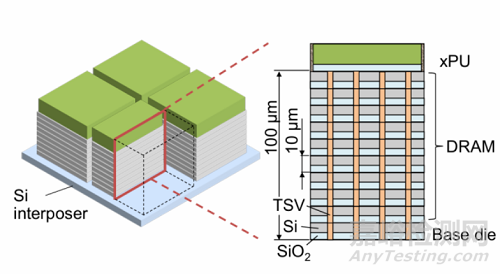
(四)封装测试:质量把控的最后防线
封装测试是 HBM 工艺的最后阶段,也是确保产品质量的关键环节。封装测试包括对 HBM 模块的电气性能测试、热性能测试、可靠性测试等多个方面。通过这些测试,可以及时发现并解决潜在的问题,确保 HBM 产品在实际应用中的稳定性和可靠性。
二、HBM 质量管理:精准把控的科学艺术
(一)Yield :层层递进的考验
HBM 是比其他 DRAM 形态更技术复杂的产品,尤其是考虑到高层的 3DIC 堆叠。封装良率无法与制造商对其更传统产品所习惯的水平相比。随着层数增加,良率会下降,因为非关键的堆叠缺陷可能累积。例如,在少数几层中可接受的小量非共面性,在更高层数时可能导致无法接受的共面性偏差。
(二)Thermal :性能与温度的平衡
与任何 3DIC 组件一样,散热是一个问题,而 DRAM 尤其不耐热。超大规模数据中心的数据显示,HBM 故障是 GPU 故障的首要原因。因此,散热管理成为 HBM 质量管理的关键环节。通过优化芯片设计、采用高效的散热材料和散热结构,可以有效降低 HBM 在运行过程中的温度,从而提高其可靠性和性能。例如,台积电的 CoWoS-S 通过硅中介层承载处理器和 HBM,采用整合式微流体冷却技术。
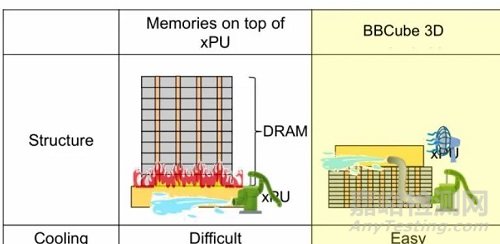
(三)设备与材料:质量的基石
HBM 的生产对设备和材料的要求极高。从 TSV 的刻蚀机、沉积设备到微凸点的电镀设备,再到封装测试的检测设备,每一个环节都需要高精度、高性能的设备来保证工艺的稳定性和一致性。同时,优质的材料也是确保 HBM 质量的关键。例如,高纯度的铜用于微凸点的电镀,高性能的绝缘材料用于 TSV 的绝缘层制备。
(四)质量控制体系:全流程的监督与优化
建立完善的质量控制体系是确保 HBM 质量的关键。从原材料的检验、生产过程中的实时监控到成品的严格检测,每一个环节都需要严格的质量控制。通过采用先进的质量控制方法和技术,如统计过程控制(SPC)、六西格玛管理等,可以及时发现并解决质量问题,持续优化生产工艺,提高产品质量。
三、HBM 的未来:技术创新与市场拓展
随着人工智能、5G、物联网等新兴技术的快速发展,对高性能计算的需求将持续增长。HBM 作为高性能计算的关键技术之一,其市场前景广阔。未来,HBM 技术将继续沿着更高带宽、更低功耗、更小尺寸的方向发展。同时,随着技术的不断进步和工艺的不断优化,HBM 的生产成本也将逐步降低,使其在更多领域得到广泛应用。
在技术创新方面,混合键合技术将成为未来 HBM 发展的重要方向。混合键合技术不仅能够提高 HBM 的性能和可靠性,还能降低其整体堆叠高度。此外,新型材料和新工艺的不断涌现,也将为 HBM 的发展提供更多的可能性。
HBM 的发展离不开行业内的合作与创新。从设备制造商到材料供应商,从芯片设计公司到封装测试企业,各方需要紧密合作,共同推动 HBM 技术的进步。同时,政府和科研机构的支持也至关重要,通过政策引导和资金支持,可以加速 HBM 技术的研发和产业化进程。
总之,HBM 作为高性能计算的关键技术,其工艺流程和质量管理的复杂性和重要性不言而喻。通过不断优化工艺流程、加强质量管理、推动技术创新,HBM 将在未来的高性能计算领域发挥更加重要的作用。让我们共同期待 HBM 技术的未来发展,为人类的科技进步贡献力量。
参考资料:
[技术前沿:HBM技术本质与演进方向]
[HBM工艺制造流程与原理 - 知乎]
[HBM TSV PVD工艺技术比较:Micron、PTi、ASE、SPIL、TSMC与UMC的优势与挑战 - 海鲸AI]

来源:芯芯有我


