您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2021-08-02 16:19
简要介绍
先进材料表征方法利用电子、光子、离子、原子、强电场、热能等与固体表面的相互作用,测量从表面散射或发射的电子、光子、离子、原子、分子的能谱、光谱、质谱、空间分布或衍射图像,得到表面成分、表面结构、表面电子态及表面物理化学过程等信息的各种技术,统称为先进材料表征方法。
先进材料表征方法包括表面元素组成、化学态及其在表层的分布测定等。后者涉及元素在表面的横向和纵向(深度)分布。
先进材料表征方法特点
表面是固体的终端,表面向外一侧没有近邻原子,表面原子有部分化学键伸向空间,形成“悬空键”。因此表面具有与体相不同的较活跃的化学性质。
表面指物体与真空或气体的界面。
先进材料表征方法通常研究的是固体表面。表面有时指表面的单原子层,有时指上面的几个原子,有时指厚度达微米级的表面层。
应用领域
航空、汽车、材料、电子、化学、生物、地质学、医学、冶金、机械加工、半导体制造、陶瓷品等。
X射线能谱分析(EDS)
应用范围
PCB、PCBA、FPC等。
测试步骤
将样品进行表面镀铂金后,放入扫描电子显微镜样品室中,使用15 kV的加速电压对测试位置进行放大观察,并用X射线能谱分析仪对样品进行元素定性半定量分析。
样品要求
非磁性或弱磁性,不易潮解且无挥发性的固态样品,小于8CM*8CM*2CM。
典型图片
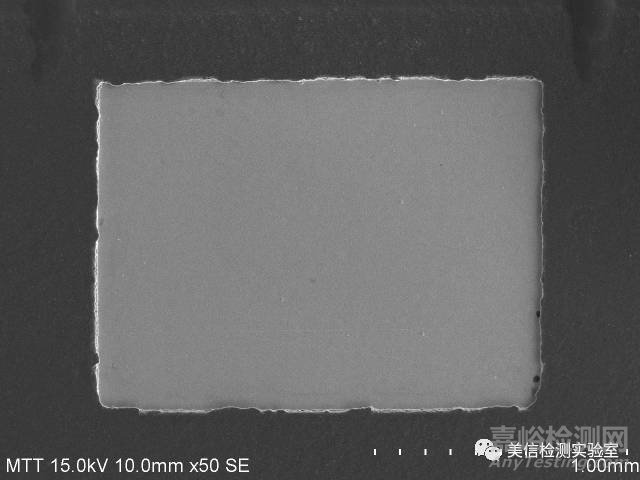
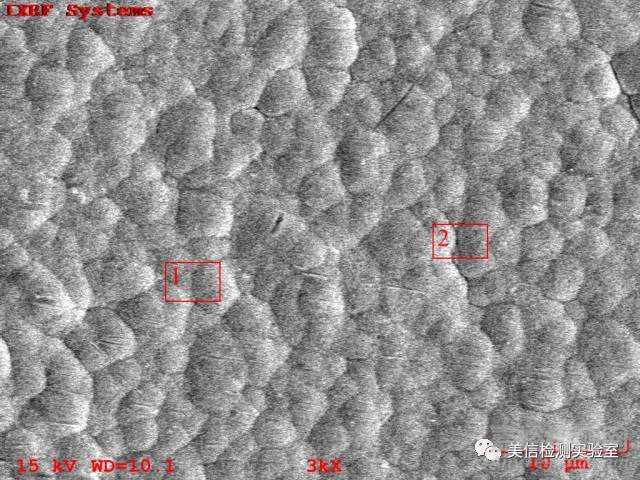
PCB焊盘测试图片
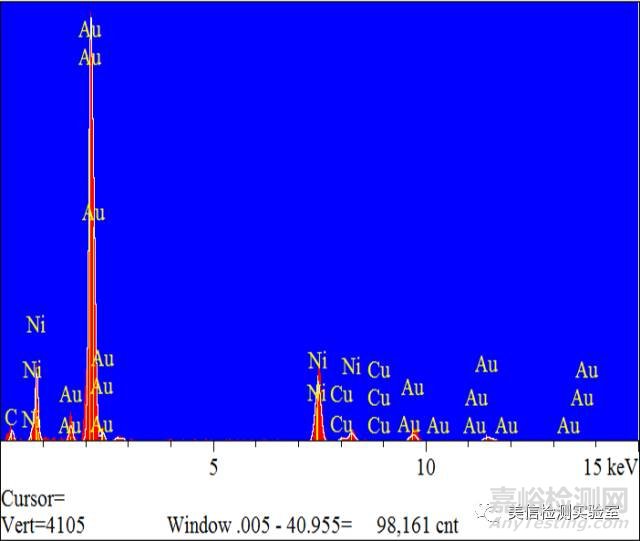

成分分析测试谱图
聚焦离子束分析(FIB)
聚焦离子束技术(FIB)
聚焦离子束技术(Focused Ion beam,FIB)是利用电透镜将离子束聚焦成非常小尺寸的离子束轰击材料表面,实现材料的剥离、沉积、注入、切割和改性。随着纳米科技的发展,纳米尺度制造业发展迅速,而纳米加工就是纳米制造业的核心部分,纳米加工的代表性方法就是聚焦离子束。近年来发展起来的聚焦离子束技术(FIB)利用高强度聚焦离子束对材料进行纳米加工,配合扫描电镜(SEM)等高倍数电子显微镜实时观察,成为了纳米级分析、制造的主要方法。目前已广泛应用于半导体集成电路修改、离子注入、切割和故障分析等。
聚焦离子束技术(FIB)可为客户解决的产品质量问题
(1)在IC生产工艺中,发现微区电路蚀刻有错误,可利用FIB的切割,断开原来的电路,再使用定区域喷金,搭接到其他电路上,实现电路修改,最高精度可达5nm。
(2)产品表面存在微纳米级缺陷,如异物、腐蚀、氧化等问题,需观察缺陷与基材的界面情况,利用FIB就可以准确定位切割,制备缺陷位置截面样品,再利用SEM观察界面情况。
(3)微米级尺寸的样品,经过表面处理形成薄膜,需要观察薄膜的结构、与基材的结合程度,可利用FIB切割制样,再使用SEM观察。
聚焦离子束技术(FIB)注意事项
(1)样品大小5×5×1cm,当样品过大需切割取样。
(2)样品需导电,不导电样品必须能喷金增加导电性。
(3)切割深度必须小于50微米。
应用实例
(1)微米级缺陷样品截面制备
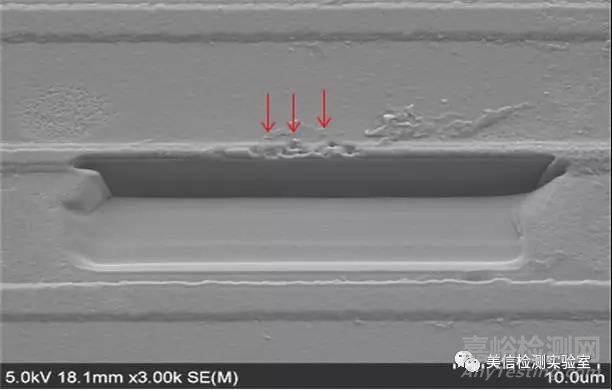
(2)PCB电路断裂位置,利用离子成像观察铜箔金相。
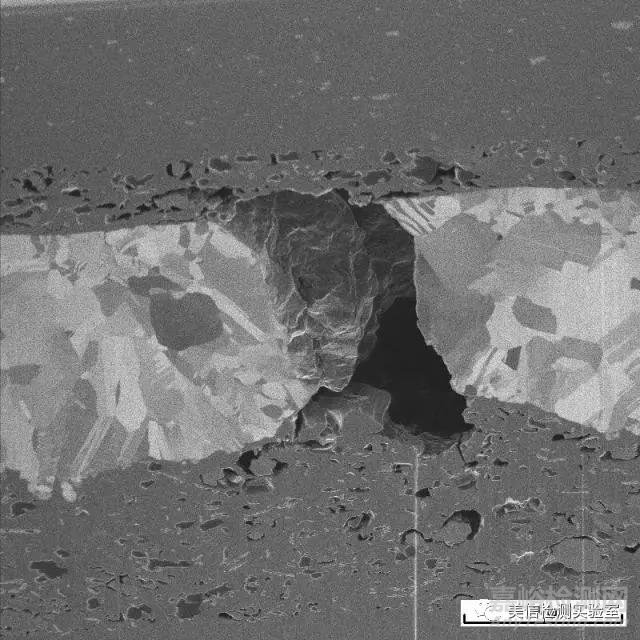
俄歇电子能谱分析(AES)
俄歇电子能谱技术(AES)
俄歇电子能谱技术(Auger electron spectroscopy,简称AES),是一种表面科学和材料科学的分析技术,因检测由俄歇效应产生的俄歇电子信号进行分析而命名。这种效应系产生于受激发的原子的外层电子跳至低能阶所放出的能量被其他外层电子吸收而使后者逸出,这一连串事件称为俄歇效应,而逃脱出来的电子称为俄歇电子,通过检测俄歇电子的能量和数量来进行定性定量分析。AES应用于鉴定样品表面的化学性质及组成的分析,其特点在俄歇电子来极表面甚至单个原子层,仅带出表面的化学信息,具有分析区域小、分析深度浅和不破坏样品的特点,广泛应用于材料分析以及催化、吸附、腐蚀、磨损等方面的研究。
俄歇电子能谱分析(AES)可为客户解决的产品质量问题
(1)当产品表面存在微小的异物,而常规的成分测试方法无法准确对异物进行定性定量分析,可选择AES进行分析,AES能分析≥20nm直径的异物成分,且异物的厚度不受限制(能达到单个原子层厚度,0.5nm)。
(2)当产品表面膜层太薄,无法使用常规测试进行厚度测量,可选择AES进行分析,利用AES的深度溅射功能测试≥3nm膜厚厚度。
(3)当产品表面有多层薄膜,需测量各层膜厚及成分,利用D-SIMS(AES)能准确测定各层薄膜厚度及组成成分。
注意事项
(1)样品最大规格尺寸为1×1×0.5cm,当样品尺寸过大需切割取样。
(2)取样的时候避免手和取样工具接触到需要测试的位置,取下样品后使用真空包装或其他能隔离外界环境的包装, 避免外来污染影响分析结果。
(3)由于AES测试深度太浅,无法对样品喷金后再测试,所以绝缘的样品不能测试,只能测试导电性较好的样品。
(4)AES元素分析范围Li-U,只能测试无机物质,不能测试有机物物质,检出限0.1%。
应用实例
样品信息:样品为客户端送检LED碎片,客户端反映LED碎片上Pad表面存在污染物,要求分析污染物的类型。
失效样品确认:将LED碎片放在金相显微镜下观察,寻找被污染的Pad,通过观察,发现Pad表面较多小黑点。

X射线光电子能谱分析(XPS)
X射线光电子能谱技术
X射线光电子能谱技术(X-ray photoelectron spectroscopy,简称XPS)是一种表面分析方法, 使用X射线去辐射样品,使原子或分子的内层电子或价电子受激发射出来,被光子激发出来的电子称为光电子,可以测量光电子的能量和数量,从而获得待测物组成。XPS主要应用是测定电子的结合能来鉴定样品表面的化学性质及组成的分析,其特点在光电子来自表面10nm以内,仅带出表面的化学信息,具有分析区域小、分析深度浅和不破坏样品的特点,广泛应用于金属、无机材料、催化剂、聚合物、涂层材料矿石等各种材料的研究,以及腐蚀、摩擦、润滑、粘接、催化、包覆、氧化等过程的研究。
X射线光电子能谱分析(XPS)可为客户解决的产品质量问题
(1)当产品表面存在微小的异物,而常规的成分测试方法无法准确对异物进行定性定量分析,可选择XPS进行分析,XPS能分析≥10μm直径的异物成分以及元素价态,从而确定异物的化学态,对失效机理研究提供准确的数据。
(2)当产品表面膜层太薄,无法使用常规测试进行厚度测量,可选择XPS进行分析,利用XPS的深度溅射功能测试≥20nm膜厚厚度。
(3)当产品表面有多层薄膜,需测量各层膜厚及成分,利用D-SIMS能准确测定各层薄膜厚度及组成成分。
(4)当产品的表面存在同种元素多种价态的物质,常规测试方法不能区分元素各种价态所含的比例,可考虑XPS价态分析,分析出元素各种价态所含的比例。
注意事项
(1)样品最大规格尺寸为1×1×0.5cm,当样品尺寸过大需切割取样。
(2)取样的时候避免手和取样工具接触到需要测试的位置,取下样品后使用真空包装或其他能隔离外界环境的包装, 避免外来污染影响分析结果。
(3)XPS测试的样品可喷薄金(不大于1nm),可以测试弱导电性的样品,但绝缘的样品不能测试。
(4)XPS元素分析范围Li-U,只能测试无机物质,不能测试有机物物质,检出限0.1%。
应用实例
样品信息:客户端发现PCB板上金片表面被污染,对污染区域进行分析,确定污染物类型。
测试结果谱图


动态二次离子质谱分析(D-SIMS)
飞行时间二次离子质谱技术
二次离子质谱技术(Dynamic Secondary Ion Mass Spectrometry,D-SIMS)是一种非常灵敏的表面分析技术,通过用一次离子激发样品表面,打出极其微量的二次离子,根据二次离子的质量来测定元素种类,具有极高分辨率和检出限的表面分析技术。D-SIMS可以提供表面,薄膜,界面以至于三维样品的元素结构信息,其特点在二次离子来自表面单个原子层(1nm以内),仅带出表面的化学信息,具有分析区域小、分析深度浅和检出限高的特点,广泛应用于物理,化学,微电子,生物,制药,空间分析等工业和研究方面。
动态二次离子质谱分析(D-SIMS)可为客户解决的产品质量问题
(1)当产品表面存在微小的异物,而常规的成分测试方法无法准确对异物进行定性定量分析,可选择D-SIMS进行分析,D-SIMS能分析≥10μm直径的异物成分。
(2)当产品表面膜层太薄,无法使用常规测试进行膜厚测量,可选择D-SIMS进行分析,利用D-SIMS测量≥1nm的超薄膜厚。
(3)当产品表面有多层薄膜,需测量各层膜厚及成分,利用D-SIMS能准确测定各层薄膜厚度及组成成分。
(4)当膜层与基材截面出现分层等问题,但是未能观察到明显的异物痕迹,可使用D-SIMS分析表面超痕量物质成分,以确定截面是否存在外来污染,检出限高达ppb级别。
(5)掺杂工艺中,掺杂元素的含量一般是在ppm-ppb之间,且深度可达几十微米,使用常规手段无法准确测试掺杂元素从表面到心部的浓度分布,利用D-SIMS可以完成这方面参数测试。
动态二次离子质谱分析(D-SIMS)注意事项
(1)样品最大规格尺寸为1×1×0.5cm,当样品尺寸过大需切割取样,样品表面必须平整。
(2)取样的时候避免手和取样工具接触到需要测试的位置,取下样品后使用真空包装或其他能隔离外界环境的包装, 避免外来污染影响分析结果。
(3)D-SIMS测试的样品不受导电性的限制,绝缘的样品也可以测试。
(4)D-SIMS元素分析范围H-U,检出限ppb级别。
应用实例
样品信息:P92钢阳极氧化膜厚度分析。
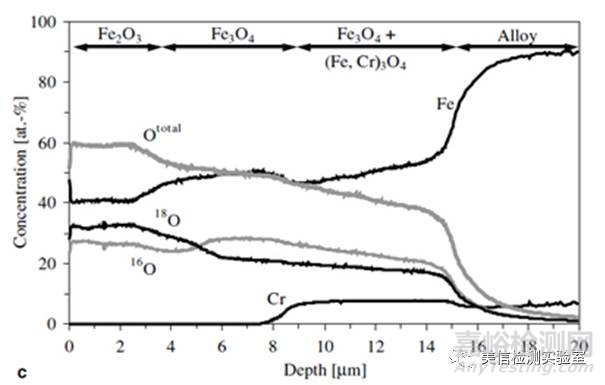
飞行时间二次离子质谱分析(TOF-SIMS)
飞行时间二次离子质谱技术
飞行时间二次离子质谱技术(Time of Flight Secondary Ion Mass Spectrometry,TOF-SIMS)是一种非常灵敏的表面分析技术,通过用一次离子激发样品表面,打出极其微量的二次离子,根据二次离子因不同的质量而飞行到探测器的时间不同来测定离子质量,具有极高分辨率的测量技术。可以广泛应用于物理,化学,微电子,生物,制药,空间分析等工业和研究方面。TOF-SIMS可以提供表面,薄膜,界面以至于三维样品的元素、分子等结构信息,其特点在二次离子来自表面单个原子层分子层(1nm以内),仅带出表面的化学信息,具有分析区域小、分析深度浅和不破坏样品的特点,广泛应用于物理,化学,微电子,生物,制药,空间分析等工业和研究方面。
飞行时间二次离子质谱分析(TOF-SIMS)可为客户解决的产品质量问题
(1)当产品表面存在微小的异物,而常规的成分测试方法无法准确对异物进行定性定量分析,可选择TOF-SIMS进行分析,TOF-SIMS能分析≥10μm直径的异物成分。
(2)当产品表面膜层太薄,无法使用常规测试进行成分分析,可选择TOF-SIMS进行分析,利用TOF-SIMS可定性分析膜层的成分。
(3)当产品表面出现异物,但是未能确定异物的种类,利用TOF-SIMS成分分析,不仅可以分析出异物所含元素,还可以分析出异物的分子式,包括有机物分子式。
(4)当膜层与基材截面出现分层等问题,但是未能观察到明显的异物痕迹,可使用TOF-SIMS分析表面痕量物质成分,以确定截面是否存在外来污染,检出限高达ppm级别。
飞行时间二次离子质谱分析(TOF-SIMS)注意事项
(1)样品最大规格尺寸为1×1×0.5cm,当样品尺寸过大需切割取样。
(2)取样的时候避免手和取样工具接触到需要测试的位置,取下样品后使用真空包装或其他能隔离外界环境的包装, 避免外来污染影响分析结果。
(3)TOF-SIMS测试的样品不受导电性的限制,绝缘的样品也可以测试。
(4)TOF-SIMS元素分析范围H-U,包含有机无机材料的元素及分子态,检出限ppm级别。
应用实例
样品信息:铜箔表面覆盖有机物钝化膜,达到保护铜箔目的,客户端需要分析分析苯并咪唑与铜表面结合方式 。



来源:Internet


