您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2022-05-21 22:54
一、概述
X射线光电子能谱(XPS)是一种先进的浅表面分析技术,基本原理是X射线束照射样品表面激发出光电子,通过对激发出来的光电子进行分析,可以得出材料表面元素组成、含量、化学状态分子结构以及化学键等方面的信息。因为激发源是X射线,所以对分析样品的表面基本无损伤。与扫描电子显微镜(SEM)+能谱(EDS)分析技术相比,XPS不仅能提供材料的元素组成,还能提供元素的价态信息,配合离子束剥离技术和变角XPS技术,还可以对材料进行深度分析和界面分析,因此XPS在电子材料、半导体、集成电路、化学化工等领域得到广泛应用。几种常见表面分析技术的对比详见表1。
表1 表面分析技术对比
|
分析技术 |
检测信号 |
能力范围 |
信息来源 |
携带信息 |
|
XPS |
光电子 |
H、He外所有元素 |
(0-10)nm |
成分、价态 |
|
EDS |
X射线 |
Be~U |
(0-3)µm |
成分 |
|
TOF-SIMS (飞行时间二次离子质谱) |
二次离子/ 有机官能团 |
几乎所有元素 |
(0-5)nm |
成分 |
|
AES (俄歇电子能谱) |
俄歇电子 |
H、He外所有元素 |
(0-3)nm |
成分、价态 |
|
UPS (紫外光电子能谱) |
光电子 |
H、He外所有元素 |
(0-10)nm |
成分、结构 |
|
ISS (离子散射谱) |
离子 |
几乎所有元素 |
1-2个原子层 |
成分 |
二、技术原理
2.1光电离原理
XPS的工作原理主要基于光电离作用。当一束光子辐照到样品表面时,光子可以被样品中某一元素的原子轨道上的电子所吸收,使得该电子脱离原子核的束缚,以一定的动能从原子内部发射出来,变成自由的光电子。在光电离的过程中,结合能可以用下面的方程表示:
Eb=hv-Ek
式中:Eb-特定原子轨道上的结合能,eV;
hv-X射线光电子能量,eV;
Ek-出射的光电子的动能,eV。
由于光电子的能量较弱,样品表面超过10nm深度的光电子基本无法逃逸出来,因此XPS的分析范围为样品浅表面10nm深度以内。在光电离过程中,出射光电子的能量仅与入射光子的能量及原子轨道结合能有关,对于特定的单色激发源和特定的原子轨道,其光电子的能量是特征的,因此我们可以根据光电子的结合能定性分析样品中元素的种类。由于原子轨道上的电子在不同的化学环境中是不一样的,存在一些微小的差异,这种差异就是元素的化学位移,利用这种化学位移可以分析元素在该样品中的化学价态和存在形式。
2.2设备原理
一台商用的XPS系统一般包含以下几个主要组件。
(1)X射线源:X射线源是X射线的发出单元,一般是用Al或Mg做阳极的X射线管;
(2)电子能量分析器:是XPS的关键组成部分,主要作用是测量电子能量分布和不同能量电子的相对强度;
(3)离子源:离子源的作用主要是对样品表面进行清洁或对样品表面进行定量剥离,在XPS系统中,最常见的是采用Ar离子源。根据分析需求的不同,可以选配单Ar离子和团簇Ar离子;
(4)真空系统:XPS采用超高真空系统,为防止样品表面被残余气体分子覆盖和避免光电子与参与气体分子碰撞而损失能量,分析室的真空度一般需优于10-8Pa;
(5)计算机系统:主要作用是控制能谱仪、采集数据以及处理分析数据。
三、应用案例
3.1元素分析
化镍金工艺的PCB焊盘表面金层厚度一般约为几十纳米,当使用SEM&EDS分析金层表面时,由于EDS收集的是特征X射线信号,而X射线的穿透能力较强,根据材料的不同,几百纳米甚至几微米深度范围的信号都能被接收到,因此金面的EDS结果中经常会发现镍元素的信号。与此同时,浅表层含量较少轻元素的信号,在EDS分析结果中会呈现较大程度的衰减现象,当特征信号低于EDS的检测限时,该元素就无法被EDS检测出来。
使用XPS分析PCB焊盘表面金层时,XPS图谱可以更准确地表征金焊盘浅表面的元素组成。从图1金焊盘表面的XPS图谱可以看到,金面浅表层存在异常元素铜和碘,异常元素及其氧化态都可能对焊盘的可焊性产生不良影响。
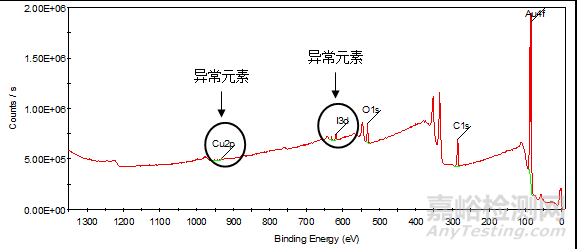
图1 金焊盘表面XPS图谱
3.2价态分析
当原子的外壳层得到或者失去电子后,由于束缚波动导致各壳层有不同程度的松弛或紧缩,从而测量出来的结合能与原始状态不同。利用这一特性可以对所测得的元素价态进行分析。
图2是使用XPS对银浆粘接的金焊盘表面进行分析,正常样品焊盘表面主要微金属硫化物,S的光电子峰在161eV,而失效品焊盘表面S的光电子峰在161eV及169eV,说明该位置存在两种价态的S元素,这表明焊盘已被另一种价态的含硫物质污染。

图2 焊盘表面XPS分析图谱
3.3深度剖析
配合离子束剥离技术,使用XPS可以对样品进行深度剖析,从而可以得出感兴趣的元素在样品深度方向上的分布情况。
图3为可焊接镍片表面XPS深度剖析的结果,其中图3(a)可以看出初始态样品表面存在较多异常元素,经过氩离子束剥离后,样品表面基本暴露纯净的镍层,如图3(b)所示。图3(c)为各元素随剥离时间增加的含量变化,可以看出剥离开始的前30s,镍片表面的污染元素含量大幅下降,说明异常元素污染仅存在于镍片的浅表层。
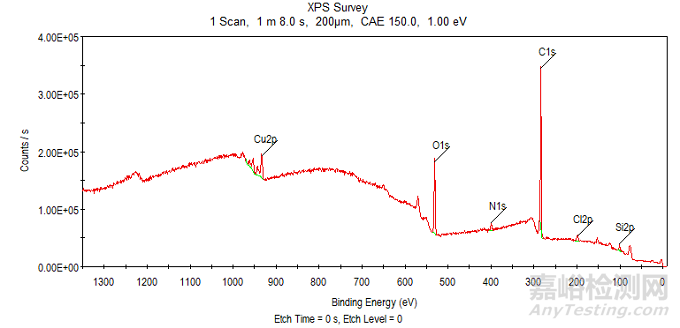
(a)初始态样品表面XPS图谱

(b)氩离子束剥离后样品表面XPS图谱
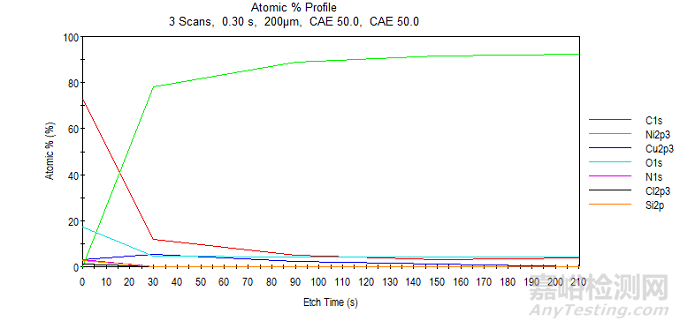
(c)元素含量与剥离时间的关系
图3 镍片XPS深度剖析图谱
四、小结
随着微电子工业发展,电子产品尺寸越来越小,失效位置和污染物也越来越小型化和微量化,这给电子组件的失效分析带来了更大的挑战。基于以上背景,XPS技术在工艺失效分析、电子材料检测等方面的应用越来越广泛。然而,没有一种技术能够涵盖所有的分析需求,如在空间分辨率和分析的便捷性方面,SEM&EDS分析技术更具优势,而在有机物的各类官能团分析方面,TOF-SIMS是更理想的分析手段,各种技术的分析能力特点各不相同,在分析过程中,我们会根据样品状态和测试需求合理选择分析手段,最终找到真实的失效原因。

来源:Internet


