您当前的位置:检测资讯 > 实验管理
嘉峪检测网 2020-10-14 09:24
材料的性能与其微观结构有着直接的关系。因此在材料的研发过程中,精确表征材料的微观结构是一项十分重要的工作,其中扫描电镜和能谱仪是研究材料微观结构最常用的设备之一。研究者在材料表征的过程力求保证数据的准确性,但有时会出现一些数据异常现象,给材料表征带来一些困扰。
来自山东大学的高学平和张爱敏两位研究人员在半导体材料表征中遇到能谱测试结果异常现象,异常现象产生原因可能与加速电压、电子束流、元素含量、原子序数、设备灵敏度等多种因素有关。为了准确了解异常现象产生的原因,并提出合理的解释,研究人员利用原子力显微镜(AFM),蒙特卡洛模拟(Monte Carlo Simulation)软件以及扫描电镜配置的能谱仪等设备对此异常现象进行了分析。
01异常现象描述
表征材料为在SiO2基体上用电化学沉积银涂层,利用日立SU-70场发射扫描电镜上配置的能谱仪进行成分表征时,结果出现异常。加速电压为15kV时,测试结果只有银元素与硅元素,没检测到氧元素;加速电压为10kV时,测试结果只有银元素,基底二氧化硅中的硅、氧元素探测不到,如图1所示。
针对这一异常现象,笔者采用扫描电镜、能谱仪、NanoIR2-fs型AFM以及蒙特卡洛软件模拟电子束综合分析该问题的产生原因。
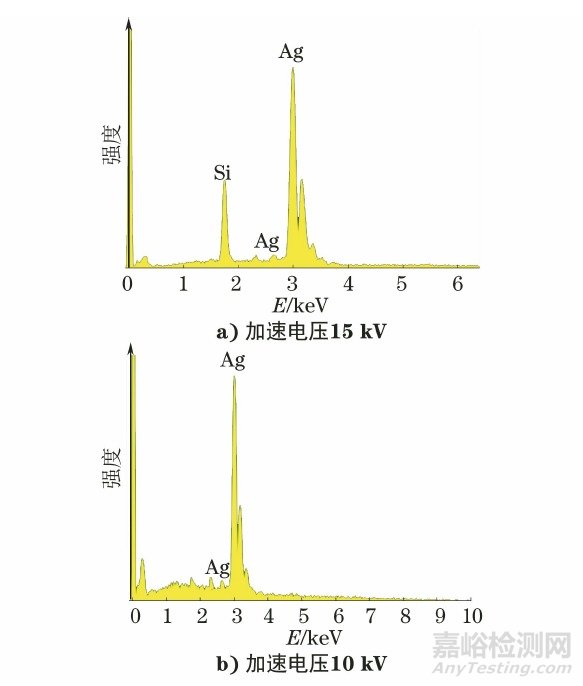
图1 不同加速电压时SiO2基体沉积银涂层的能谱
02样品涂层厚度表征
多层膜厚度的定量表征是分析测试领域的一个难点问题,部分研究者将样品切断于扫描电镜下观察断口形貌,进而测量涂层厚度。但此方法存在断口不整齐、涂层撕裂甚至涂层脱落等问题,导致涂层厚度测量不准确。笔者采用AFM定量测试涂层厚度,高度分辨率可达到0.2nm。
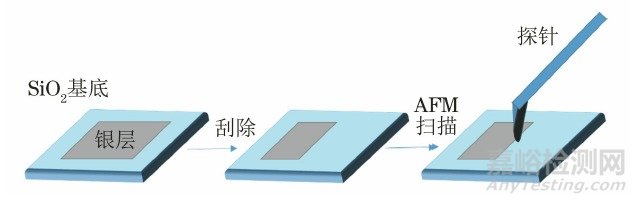
图2 AFM测量表面银层厚度示意图
首先,将样品表面部分纳米银涂层用刀片轻轻刮除,如图2所示,然后将样品置于AFM 样品台上,先通过光学显微镜找到样品中银层被刮除的界面,在界面处扫描,根据样品表面高度信息,测试得到银层的厚度,如图3所示。根据原子力显微镜图片高度信息,计算得到银层厚度为400nm。

图3 表面银层厚度的AFM测试结果
03蒙特卡洛模拟
利用蒙特卡洛模拟软件对不同条件下银层的信号激发情况进行模拟分析。
3.1不同电压下元素银的激发深度模拟
模拟日本日立产SU_70场发射扫描电镜不同作条件下,银元素的激发深度。加速电压为15kV,工作距离为15mm,模拟结果如图4a)所示;该条件下,银的激发深度为500nm 左右。加速电压为10kV,工作距离为15mm,模拟结果如图4b)所示;该条件下,银的激发深度为200nm左右。

图4 不同加速电压下银元素的模拟激发深度
3.2样品实际状态蒙特卡洛模拟
基体SiO2上有银涂层,厚度为400nm,蒙特卡洛模拟结果如图5所示;图5a)显示10kV的加速电压下,高能电子束没能击穿银层,因此能谱仪检测到的元素只有银。图5b)显示15kV的加速电压下,有部分高能电子束激发到SiO2 基体中,能激发出部分硅和氧的特征X 射线。轻元素氧的特征X射线能量Kα=0.525keV,产率小与能量低,很容易就被400nm厚度的银层吸收掉,对谱峰结果产生了严重干扰;硅元素的特征X 射线能量Kα=1.74keV,Kβ=1.838keV,产率与能量较高,能够穿透400nm厚度的银层;因此,只有部分硅元素的特征X射线能够穿透银涂层进入能谱探头,是能谱仪检测结果中出现银元素和硅元素的原因。
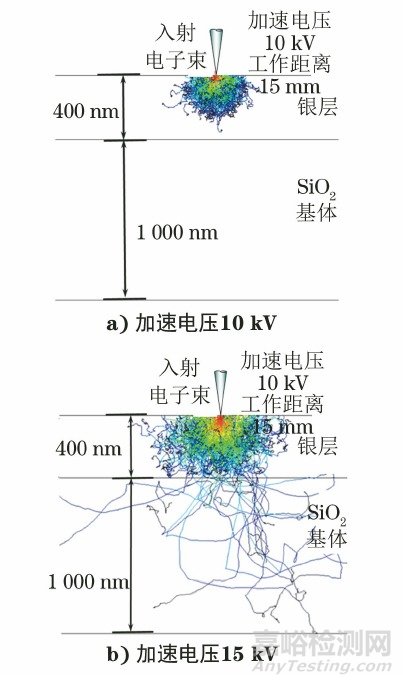
图5 样品实际状态下的蒙特卡洛模拟
结论
氧元素的特征X射线能量Kα=0.525keV,该能量能级较低难以穿透400nm厚度的银涂层,硅元素的特征X 射线能量Kα =1.74keV,Kβ =1.838keV,能级较高,能够穿透该厚度的银涂层。
对于多层材料,样品表面逸出的X射线受到样品激发深度、特征X 射线能量、多层材料的层厚等多方面影响,在实际分析过程中要充分考虑样品的实际情况(层厚、材料成分)以及测试条件(加速电压等),综合分析能谱的测试结果,方能获得正确的材料信息。

来源:《理化检验-物理分册》


