您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2018-09-13 10:06
关于无损膜厚测试,很多品质工程、项目开发人员对该领域都比较陌生,常常询问:“这个设备能分析这个金属成分吗?”而对于检测人员,往往受制于膜厚设备的不可自主编程性以及金属成分分析需要很强的专业性,导致对设备的熟悉程度仅仅局限于操作。为揭开膜厚测试及金属成分分析的神秘面纱,我们很有必要详细的探讨一下。
膜厚测试仪分类

磁感应测量原理
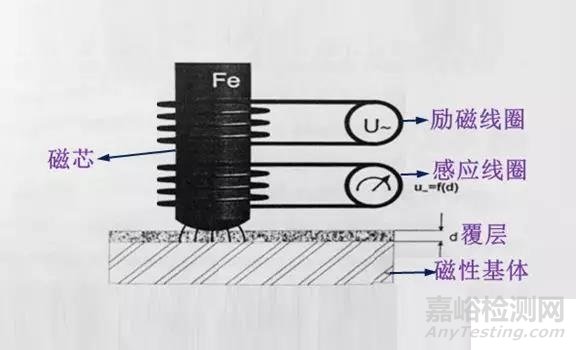
磁感应原理,即是利用从测头经过非铁磁覆层流入铁磁基体的磁通大小,测定覆层厚度。也可以通过测定对应的磁阻大小,表示其覆层厚度。
覆层越厚,磁阻越大,磁通越小。利用磁感应原理的测厚仪,原则上导磁基体上要有非导磁覆层厚度。一般要求基材导磁率在500μ以上。如果覆层材料也有磁性,则要求与基材的导磁率之差足够大(如在钢表面镀镍)。当磁芯上绕着线圈的测头放在被测样本上时,仪器自动输出测试电流或测试信号。早期的产品采用指针式表头,测量感应电动势的大小,仪器将该信号放大后转换成覆层厚度。电路设计引入稳频、锁相、温度补偿等新技术,利用磁阻来调制测量信号。先进的设备还采用专利设计的集成电路,引入微机,使测量精度和重复性达到大幅度的提高(几乎达到10倍以上)。现代的磁感应测厚仪,分辨率达到0.1um,允许误差达1%,量程达10mm。

电涡流测量原理
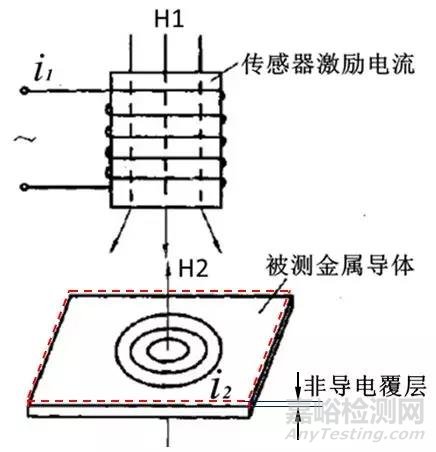
高频交流信号在测头线圈中产生电磁场,测头靠近金属导体时,形成涡流。测头距离金属导电基体愈近,则涡流愈大,反射阻抗也愈大。这个反馈作用测量了测头与导电基体之间距离的大小,也就是导电基体上非导电覆层厚度的大小。
由于这类测头专门测量非铁磁金属基材上的覆层厚度,所以通常称为非磁性测头。非磁性测头采用高频材料作为线圈铁芯,例如铂镍合金或其它新材料。
与磁感应原理比较,主要区别是测头不同,信号的频率不同,信号的大小、标度关系不同。与磁感应测厚仪一样, 涡流测厚仪也达到了分辨率0.1um,允许误差1%,量程10mm的高水平。
覆层材料有一定的导电性,通过校准后也可准确测量,但要求两者的导电率之比至少相差3-5倍(如铜镀铬)。虽然钢铁基体为导电体,但这类材料还是采用磁性原理测量较为合适。

小结
利用磁性法(包括变磁阻法和电涡流法)都要求涂层为非磁性涂层,尚未发现有利用该方法的涂层测厚产品是针对磁性涂层的。在国家标准GB/T 4957-2003《非磁性金属基体上非导电覆盖层厚度测量涡流方法》(与国际标准IS02360-2003对应)中,对涡流测厚仪的标准,操作程序和影响测量精度的因素及其注意事项作了详细的阐述。其中有关影响测量精度因素的条款,应视作涡流涂层测厚仪开发应用必须遵循的指导性文件。
仪器及其校准和操作应使覆盖层厚度能测准到真实厚度的10%以内。如果测量小于 5μm的覆盖层厚度,推荐取几次读数的平均值。覆盖层厚度小于 3μm时,可能达不到这样的准确度。
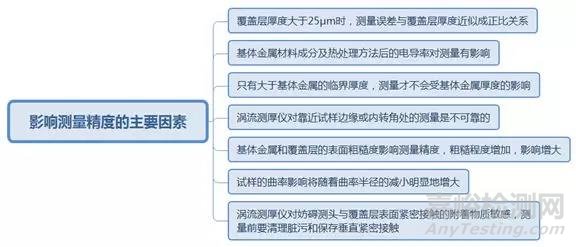
X射线
X射线的能量穿过金属镀层的同时,金属元素其电子会反射其稳定的能量波谱。通过这样的原理,设计出膜厚测试仪,又称金属镀层厚度测量仪,其不同之处为其既是薄膜厚度测试仪,也是薄膜表层金属元素分析仪,因响应全球环保工艺准则,故目前市场上最普遍使用的都是无损薄膜X射线荧光镀层测厚仪。
台式的荧光X射线膜厚测试仪,是通过一次X射线穿透金属元素样品时所产生低能量的光子,俗称为二次荧光,,再通过计算二次荧光的能量来计算厚度值·
X射线和紫外线与红外线一样,是一种电磁波。可视光线的波长为0.000001 m (1μm)左右。对某物质进行X射线照射时,可以观测到3种主要的X射线。

X射线衍射装置(XRD)(X-Ray Diffraction)
XRD的基础原理是X射线的相干散射,布拉格公式、晶体理论.

晶体衍射布拉格定律:

式中λ为X射线的波长,n为任何正整数,又称衍射级数。其上限为以下条件来表示:

即是当间距大于波长一半的面族时才可能给出衍射,以此求纳米粒子的形貌。

应用已知波长的X射线来测量θ角,从而计算出晶面间距d,这是用于X射线结构分析;或者应用已知d的晶体来测量θ角,计算出特征X射线的波长,再根据已有资料查表得出试样中所含的元素。


X射线衍射仪一般附带有衍射图处理分析软件的计算机系统,分析软件有Pcpdgwin、Search match、High score和Jade这四种软件,其中,High score和Jade是常规X射线衍射仪最常用的软件。
如我们通过运用Jade软件,可以对被测物进行物相检索、计算物质质量分数、计算结晶化程度、计算晶粒大小和微观应变、计算点阵常数、计算残余应力等等。
XRD分析是一门专业性较强的科学技术研究,需要投入大量时间和精力才能学会,不是通过读懂其中一个图谱就能解决的。
X射线衍射装置(XRD)和萤光X射线装置(XRF)的主要区别:
X射线衍射装置(XRD)能得到某物质中的结晶信息,测定晶体结构。
萤光X射线装置(XRF)能得到某物质中的元素信息(物质构成,组成和镀层厚度),元素的定性、定量分析
比如用不同的装置测定食盐氯化钠(NaCl)时,从萤光X射线装置得到的信息为此物质由钠(Na)和氯(Cl)构成,而从X射线衍射装置得到的信息为此物质由氯化钠(NaCl)的结晶构成。单纯地看,也许我们会认为具备测定结晶状态的X射线衍射装置(XRD)更好,但当测定含多种化合物的物质时只用衍射装置(XRD)就很难判定,必须先用萤光X射线装置(XRF)得到元素信息后才能进行定性分析。
萤光X射线装置(XRF)(X-Ray Fluorescence)
XRF基于莫斯莱定律,以特征X射线为基础。

所有 XRF 光谱仪的基本概念都是源、样品和检测系统。源照射样品,检测仪测量从样品发射的荧光辐射。在大多数情况下,XRF 的源是 X 射线管。替代方案是放射源或同步加速器。XRF 仪器主要有两种类型:
能量色散 X 射线荧光 (EDXRF) :利用脉冲高度分析器直接将光谱根据能量不同进行分开。
波长色散 X 射线荧光 (WDXRF):使用合适的晶体将发射光谱根据波长不同进行分开。
能量色散 X 射线荧光光谱仪工作原理
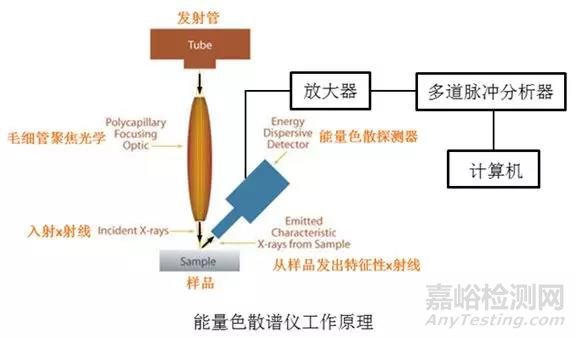

X 射线光学晶体可用于增强这两种 XRF 仪器。对于常规 XRF 仪器,样品表面典型焦斑尺寸的直径范围从几百微米到几毫米不等。多毛细管聚焦光学晶体从发散 X 射线源收集 X 射线,并将它们引导至样品表面上形成直径小到几十微米的小聚焦光束。由此增加的强度以小焦斑传递到样品,可增强用于小特性分析的空间分辨率和用于微 X 射线荧光应用的微量元素测量性能。双曲面弯晶光学晶体将高强度微米级单色 X 射线束引导至样品表面,用于加强元素分析。



来源:测量者


