您当前的位置:检测资讯 > 检测案例
嘉峪检测网 2022-03-11 23:29
主板BGA开裂失效分析
背景:
客户生产的主板上的BGA在第二次过炉后出现开裂现象,断裂发生在组件侧。故委托实验室进行分析,以便找到失效原因。
分析结果:
1.荧光剂浸泡+冷拔+断口分析结果,排除“金脆”引发BGA开裂的可能性。
2.动态翘曲度测试结果表明,PCB四连板在加热过程中变形明显,呈现中间下凹、左右两边上凸的形态。且其在冷却完成后翘曲最严重。
3.开裂焊点统计结果显示,开裂多发生在未植球的空白区域附近,且部分区域的焊点开裂更严重,与翘曲有一定的关联性。综合各测试结果,推测离PCB中间区域越近的BGA锡球,越容易产生开裂。
4.原物料切片后发现部分锡球存在原始微裂纹。推测有原始微裂纹的锡球在焊接过程中,PCB板翘曲变形,使得裂纹扩张,造成锡球开裂。
失效症状:
BGA开裂
根本原因:
BGA原物料具有原始微裂纹,PCB在焊接过程翘曲变形,使裂纹扩张,造成开裂。
改善建议:
1.管控BGA在焊接过程中的翘曲。
2.严格管控BGA的来料品质。

客户生产的主板上的BGA在第二次过炉后出现开裂现象,断裂发生在组件侧。
PCB表面处理为化镍浸金。
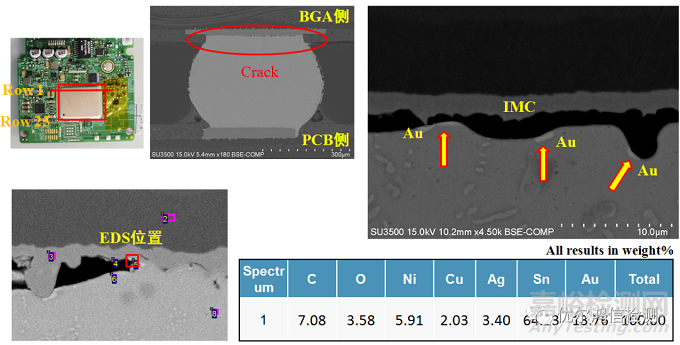
对不良BGA进行切片,在第4排锡球(Row4)发现有开裂,开裂发生在BGA侧,裂纹沿着IMC扩展,且断口焊锡有重熔现象。推断开裂和翘曲有关,可能发生在第一次过炉的降温阶段或者第二次过炉的升温阶段。
此外在断口部分区域发现有Au元素富集现象,需对“金脆”现象进行排除。
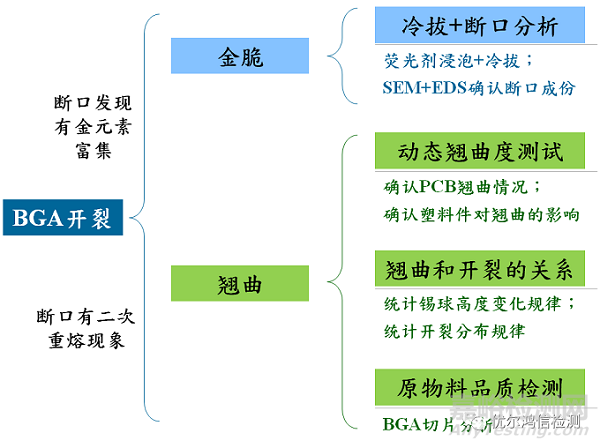
冷拔+断口分析
将主板浸泡在浓度为3%的荧光剂水溶液,抽真空,干燥后,对BGA位置进行冷拔。在紫外光下观察焊点发光情况,确认开裂状况。
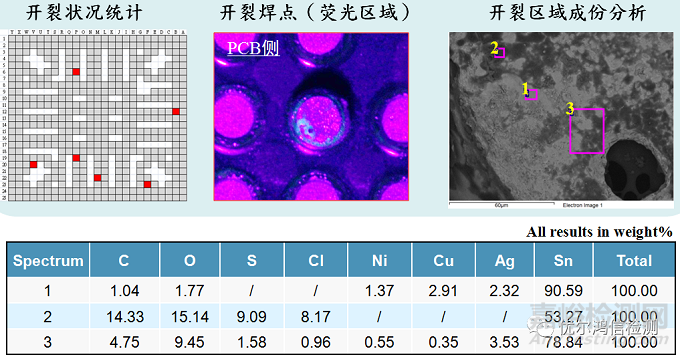
对焊点开裂区域进行检查,未发现明显的Au元素富集,排除“金脆”引发BGA开裂的可能性。
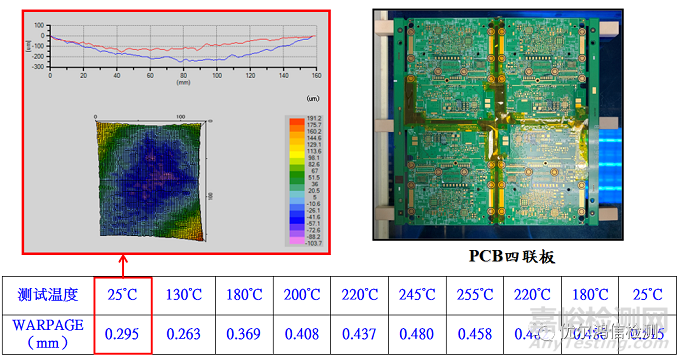
对PCB四联板进行动态翘曲度测试,结果如上所示。PCB在室温即存在一定扭曲,中间下凹、左上角和右下角有一定凸起。
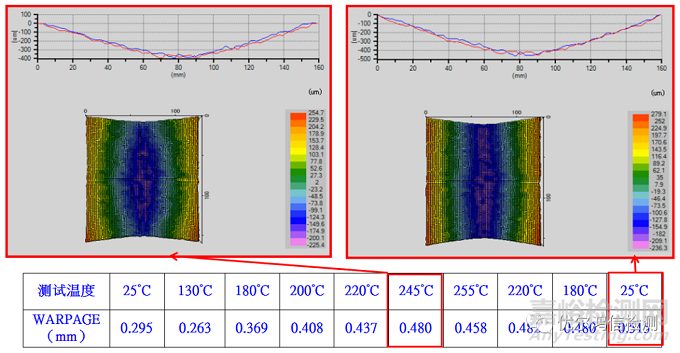
PCB四联板在升温过程中会逐渐软化变形,呈现中间下凹、左右两边上凸的形态,一直到降温结束,这种形态都没有明显改变。在最后冷却到室温时,出现了一个翘曲的极值。所以此PCB在第一次过炉后,冷却完毕会出现一个最大翘曲。

对仅B面打件的小板进行动态翘曲度测试,结果如上所示。未发现明显的翘曲变化。单独的小板翘曲并不严重,小板上塑料件的存在也并未加剧PCB的翘曲。

对不良品的BGA锡球高度进行统计。结果显示BGA锡球呈现中间高两边低的现象,锡球高度受到了翘曲的影响。
BGA左侧的锡球,裂纹多出现在左边;右侧的锡球,裂纹多出现在右边。与翘曲有一定的关联性。
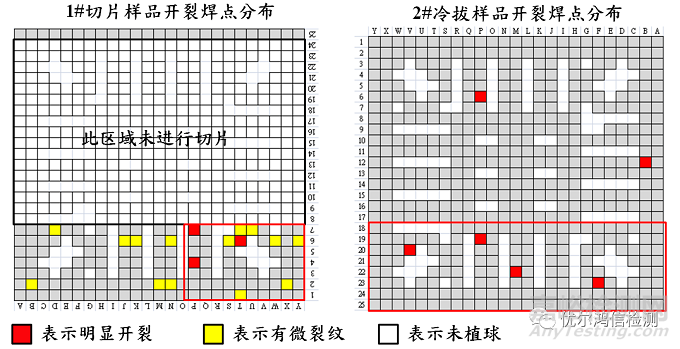
对不良BGA锡球开裂状况进行统计。结果表明,开裂多发生在未植球的空白区域附近,且部分区域(红框位置)的焊点开裂更严重。
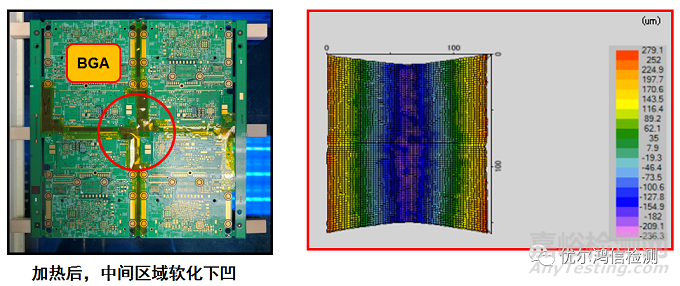
PCB四联板在加热过程中,中间区域(红圈位置)会出现软化下凹,变形明显。
综上推测:离PCB中间区域越近的BGA锡球,越容易产生开裂。
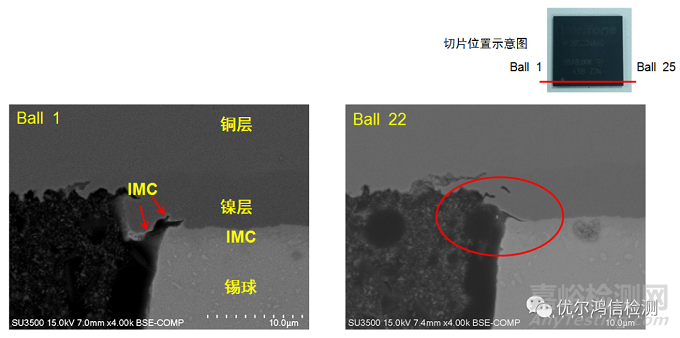
对1pcsBGA原物料进行切片,发现部分锡球的边角已经有细小缺口或微裂纹。第一排25个锡球里有三个球发现微裂纹或小缺口。
小缺口区域有IMC生成,推测其产生原因可能和植球时的边角退润湿有关。
综上,推测有原始微裂纹的锡球在焊接过程中,PCB板翘曲变形,使得裂纹扩张,造成锡球开裂。
结论
1.主板的BGA 开裂发生在组件侧IMC层且断口有二次重熔现象。断口部分区域有Au元素富集现象。
2.荧光剂浸泡+冷拔+断口分析结果,排除“金脆”引发BGA开裂的可能性。
3.动态翘曲度测试结果表明,PCB四连板在加热过程中变形明显,呈现中间下凹、左右两边上凸的形态。且其在冷却完成后(255℃降至25℃)翘曲最严重。
4.开裂焊点统计结果显示,开裂多发生在未植球的空白区域附近,且部分区域的焊点开裂更严重,与翘曲有一定的关联性。综合各测试结果,推测离PCB中间区域越近的BGA锡球,越容易产生开裂。
5.原物料切片后发现部分锡球存在原始微裂纹。推测有原始微裂纹的锡球在焊接过程中,PCB板翘曲变形,使得裂纹扩张,造成锡球开裂。
·改善建议
1.管控PCB在焊接过程中的翘曲。
2.严格管控BGA的来料质量。

来源:Internet


