您当前的位置:检测资讯 > 检测案例
嘉峪检测网 2025-07-24 18:55
案例背景
故障场景:该MOS,在ECU生产过程中,通电测试,该MOS均正常。在客户生产过程中,通电测试,测试后出现异常,故障件拆件分析后,GS阻抗为70ohm。
分析过程
外观检查
对取板样品外观检查;
发现#NG外观存在刮伤、沾锡、沾污。

X-ray
为确认失效MOS管内部结构,封装是否存在明显缺陷,利用X-ray对其进行无损分析。
X-ray结果显示:X-RAY显示目标MOS管内部未见明显异常。
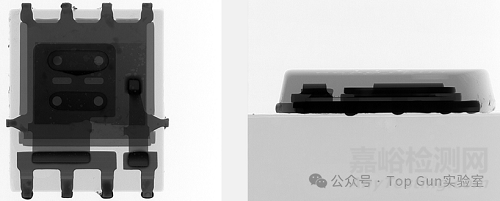
SAT利用超声扫描对样品内部结构进行观察,检查是否存在异常;结果显示:未见明显异常特征。
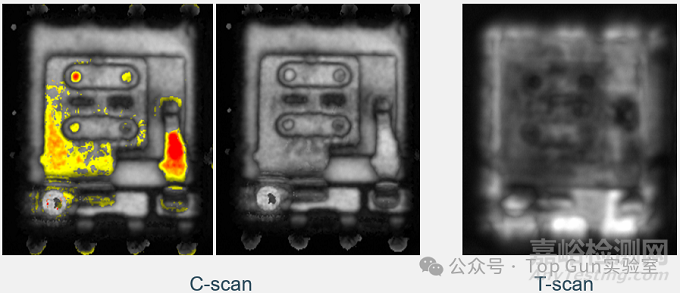
电性IV检查
为确认异常现象MOS管电性情况,对MOS管D-S、G-S分别上电;
测试结果显示:#NG样品D-S、G-S short。


Decap为确认异常现象MOS管内部是否存在异常,对MOS管进行开封取die观察;观察结果显示:MOS芯片表面未发现异常现象。

定位分析前面分析可知:芯片表面观察未发现异常现象,为确认样品短路原因对样品做热点定位。观察结果显示:#NG终端存在热点。
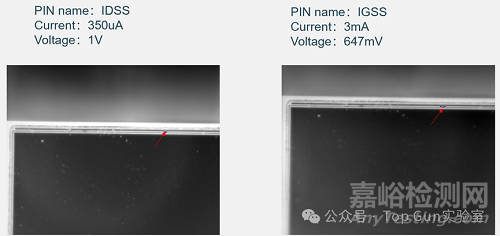
深度解析FIB对异常样品#NG发现的热点进行FIB切片分析,观察热点下层是否存在异常。测试结果显示:在芯片终端发现crack。
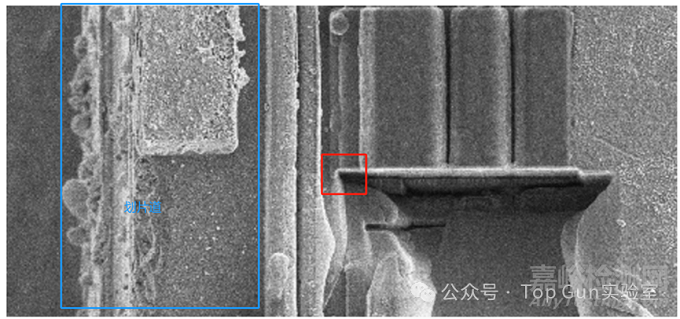
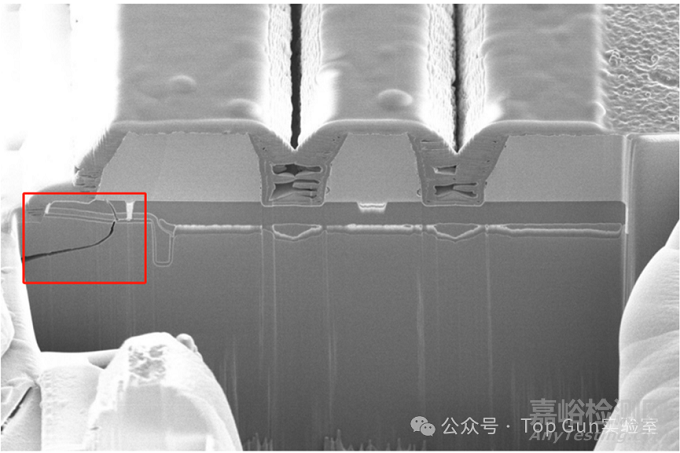
综合分析
MOS管在上板测试发现极间阻抗异常:(1)外观检查未发现失效的MOS管存在裂纹、破损等异常,未发现焊接存在开裂痕迹;(2)X-ray检查、超声扫描等无损分析未发现失效MOS管内部明显异常,IV测试发现异常品存在极间短路;(3)开封取die后,芯片表面未见明显失效特征;(4)为确定短路异常发生位置,对异常样品做热点定位,发现终端存在热点。(5)对热点位置进行FIB切片,在边缘发现crack,通过侧面观察发现侧面划片道存在开裂;
综合分析:MOS管失效原因就是封装划片过程中,划片崩裂芯片边缘,在后续老化测试过程中加剧裂纹生长,蔓延至芯片内部,造成极间短路

来源:Internet


