您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2022-07-27 19:10
光刻是集成电路和半导体器件制造工艺中的关键性技术,其工艺质量直接影响器件成品率、可靠性、器件性能以及使用寿命等参数指标的稳定和提高,就目前光刻工艺而言,工艺设备的稳定性、工艺材料以及人工参与的影响等都会对后续器件成品率及可靠性产生影响。针对此类问题,本文首先介绍光刻和电子束曝光的基本工艺流程,之后对工艺过程中缺陷来源进行分析。
1.光刻工艺流程
集成电路制造中,在硅片表面涂上光阻薄层作为保护膜,经过光照、显影,在光阻上留下掩模版的图形,对选定区域进行刻蚀,或进行离子注入,形成器件和电路结构(图1)。随着集成电路的集成度不断提高,器件的特征尺寸不断减小,期望进一步缩小光刻图形的尺寸,目前已经开始采用线宽为5-7nm的加工技术。
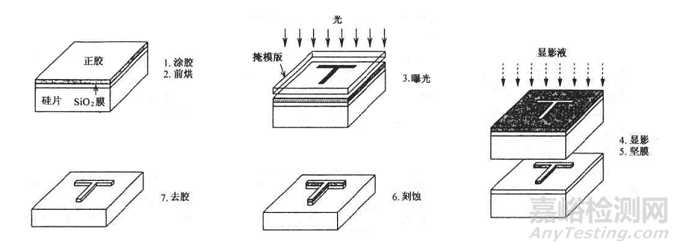
图1 光刻(包含刻蚀)工艺基本流程
(1)涂胶,将加工好的硅片清洗并脱水、烘干;之后把硅片放在一个平整的金属托盘上,有小孔与真空管相连,硅片就被吸在托盘上,硅片与托盘一起旋转;将光阻溶液喷洒到硅片表面上;加速旋转托盘(硅片),直至达到需要的旋转速度;达到所需的旋转速度后,保持一定时间的旋转。光阻的膜厚与本身的黏性和托盘旋转速度有关,其膜厚越薄,均匀性越好;
(2)前烘,在液态的光阻中,溶剂的成分占65%-85%,经过甩胶之后,虽然液态的光阻已经成为固态的薄膜,但仍含有10%-30%的溶剂,涂胶以后的硅片,需要在一定的温度下进行烘烤,使溶剂从光阻内挥发出来;
(3)曝光,其主要目的是将掩模版上的图案转移到晶圆上,当光线通过掩模版到达光阻时,使光阻的光敏物质发生反应分解,达到图像转移的目的。此外,由于集成电路的制程由很多层组成,所以层与层之间的对准关系也很重要。
(4)显影,将显影液全面地喷在光阻上,或将曝光后的样片浸在显影液中几十秒钟,则正型光阻的曝光部分(或负胶的未曝光部分)被溶解。显影后的图形精度受显影液的浓度、温度以及显影的时间等影响,显影后用纯水清洗;
(5)坚膜,为使残留在光阻中的有机物溶液完全挥发,提高光阻和基片的粘接性及光阻的耐腐蚀能力,通常将基片在120-200℃温度下烘干20–30分钟;
后续对其进行刻蚀、去胶就能在硅片上面得到所需图案。
2.电子束曝光流程
电子束曝光(Electron beam lithography, EBL)是聚焦电子束在覆盖有电子抗蚀剂敏感膜的表面上选择性曝光实现图形化的微加工技术,属于无掩模光刻的一类技术。早在1960年研究者就能在薄的衬底上实现了20 nm的EBL分辨率。EBL极高的分辨率归因于极小的电子波长,电子只需要在10 kV的电压下加速(普通SEM电子枪加速电压为3~30 kV),其波长约为0.01 nm,然而目前世界上最先进的极紫外光源的波长仍然在7~10 nm的量级。
EBL设备通常是在普通的SEM基础上稍作改装就可以实现的,EBL设备在核心的电子枪内部仅仅比SEM多一个束闸,束闸的作用是在两个极板之间施加一个电场以控制电子束的快速开关,使电子束在样品上有选择的曝光部分区域,曝光过的区域,在显影液中被溶解掉,形成图形化的软模板。高分辨率的EBL技术在半导体产业和科学研究中都有着重要的作用,在半导体产业领域如小批量集成电路的制造、高分辨率掩模版的制造和新器件原型的开发,在科学研究领域如纳米尺度新结构的实现和新型纳米材料的性能研究等。
下面以制作金阵列为例,介绍EBL的基本工艺流程[1]。
(1)旋涂,以聚甲基丙烯酸甲酯(PMMA)作为光阻,用主体可导电的平整基片作为衬底,如掺杂的硅片、SiO2/Si、导电玻璃和金属箔等,用旋涂工艺在衬底上涂覆光阻,先涂一层甲基丙烯酸甲酯(MMA),作用是去胶时更彻底及减少蒸金等外延工艺粘侧壁现象,再涂一层PMMA作为电子抗蚀剂,然后在对流烘箱或者热板上前烘去除有机溶剂;
(2)曝光及显影,用束闸控制电子束的曝光区域,被电子束曝光后的区域内PMMA分子链发生断裂,分解成更短链或者MMA单体,在显影液中被溶解,显影之后使用去离子水或者酒精等不溶解光阻的溶剂清洗阻断显影过程,实现定影,形成图案化的软模板;
(3)蒸镀,当真空度低于饱和蒸汽压时,金丝在高温下发生汽化后,在光阻和衬底上成膜,也可以使用磁控溅射、原子层沉积、化学气相沉积等其它外延工艺形成金膜;
(4)去胶,使用丙酮、四氢呋喃和氯仿等有机溶剂将光阻溶解,光阻上和衬底不相连的金属膜将被剥离,从而获得所需要的各种图案。
3.缺陷产生的原因
经有关工艺分析资料和五所分析中心近三年电源芯片失效案例表明,光刻引入的工艺缺陷几乎占整个芯片工艺流程总缺陷的50%。除了掩模版质量引起的缺陷外,大部分都是在进行光刻工艺的操作过程中由于人员行为、操作介质、环境因素等引起的随机分布点缺陷。根据具体的操作步骤,总结其可能的缺陷[2]。
3.1晶圆缺陷
晶圆翘曲度比较大,基底不平整,会导致光刻图形尺寸偏差,尤其是晶圆边缘位置;晶圆表面清洗处理不良,表面有杂质颗粒等,使光阻里面和表面有灰尘的地方对曝光和刻蚀起到阻碍作用,同时也降低了胶膜与基底的粘附力,容易形成小岛或针孔似的缺陷。
3.2光阻缺陷
光阻管路里有气泡,做旋涂的时候会造成气泡,同样会对曝光和刻蚀起到阻碍作用。光阻管路或去离子水有杂质粒子,那么旋涂曝光后会造成图形断开。光阻有结晶或显影不够完全,会造成图案断开不彻底。
3.3曝光
如果掩模版上出现质量问题,使得需要透光的位置被缺陷(小岛)遮挡住,或不需要透光的位置出现针孔,或者是制作掩模版时,图形边缘处理不好而留下有锯齿,从而掩模版上是针孔或小岛等缺陷也被同时复制到了硅片上。掩模版上的缺陷多数情况是在掩模版的制作过程中形成的,可能是掩模版材料选择不正确,也可能是掩模版制作工艺的问题,或者是在光刻工艺的架版过程中不小心划伤造成的。
3.4显影
显影过程中有氮气和去离子水共同作用,如果参数设置不够好,两者会产生相互应力,造成显影不完全。
3.5工艺过程损伤
涂在基底表面上的光阻,其机械强度比较弱,在曝光、显影冲洗、显微镜下观察、蚀刻及最后的清洗处理等过程中人员的粗心大意都会在基底表面造成划伤缺陷。另外,对于接触式曝光方式,在对位的过程中,掩模版与涂有光阻的基底表面接触摩擦力大小控制不当,也会造成划伤缺陷。
4.总结
当我们弄清楚了光刻工艺中各种缺陷产生的机理和原因,就能有针对性的采取各种措施,在实际工作中避免和消除各种缺陷的出现,使器件的质量得到进一步提升。
参考文献
[1] Wu G, Cao F, Zhao P, et al.Novel periodic bilayer Au nanostructures for ultrasensitive surface-enhanced Raman spectroscopy [J] Advanced Materials Interfaces, 2018, 5(20): 1800802
[2]邓涛, 李平, 邓光华. 光刻工艺中缺陷来源的分析[J].半导体光电, 2005, 26(3):3.

来源:赛宝可靠性


