您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2018-10-21 18:21
影响无铅焊点可靠性的因素
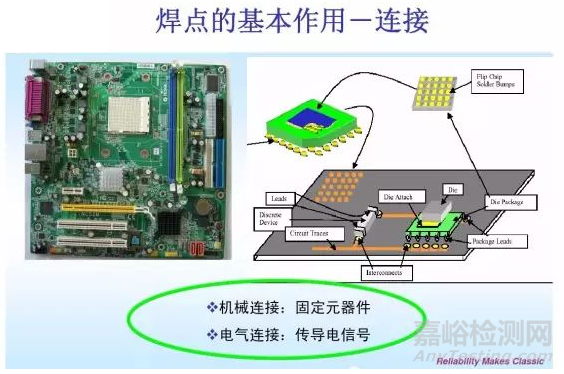
1、对无铅焊料的性能要求
微电子领域使用的焊料有着很严格的性能要求,无铅焊料也不例外,不仅包括电学和力学性能,还必须具有理想的熔融温度。从制造工艺和可靠性两方面考虑,表1列出了焊料合金的一些重要性能[4,5]。

2、影响无铅焊点可靠性的因素
鉴于无铅化焊点可靠性方面目前仍存在许多问题,有必要对此进行分析。无铅焊点的可靠性问题主要来源于:焊点的剪切疲劳与蠕变裂纹[7,8,9]、电迁移[8,10]、焊料与基体界面金属间化合物形成裂纹[7,8,11,12]、Sn晶须生长引起短路[7,8],电腐蚀和化学腐蚀问题r¨等。以下我们主要从设计、材料与工艺角度介绍影响无铅焊点可靠性的一些因素。
(1)设计:PCB的合理设计问题。如焊盘设计不合理、发热量大的元件密集分布、相邻高大元件在回流焊时产生“高楼效应”、形成热风冲击等。
(2)材料:焊料的选择极为重要。目前,大多采用锡银铜合金系列,液相温度是217℃-221℃,这就要求再流焊具有较高的峰值温度,如前所述会带来焊料及导体材料(如Cu箔)易高温氧化、金属间化合物生长迅速等问题。因为在焊接过程中,熔融的钎料与焊接衬底接触时,由于高温在界面会形成一层金属间化合物(IMc)。其形成不但受回流焊温度、时间的控制,而且在后期使用过程中其厚度会随时间增加。研究表明界面上的金属间化合物是影响焊点可靠性的一个关键因素。过厚的金属间化合物层的存在会导致焊点断裂、韧性和抗低周疲劳能力下降,从而导致焊点的可靠性降低。以当前最为成熟的Sn-Ag系无铅焊料为例,由于熔点更高,相应的再流焊温度也将提高,加之无铅焊料中Sn含量都比Sn-Pb焊料高,这两者都增大了焊点和基体间界面上形成金属问化合物的速率,导致焊点提前失效[13]。另外,由于无铅焊料和传统Sn-Pb焊料成分不同,因而它们和焊盘材料,如Cu、Ni、AgPd等的反应速率及反应产物可能不同,焊点也会表现出不同的可靠性。同时焊料和助焊剂的兼容性也会对焊点的可靠性产生非常大的影响。有研究表明:焊料和助焊剂各成分之间不兼容会导致附着力减小。此外,由于热膨胀系数不匹配,又会加快焊料周期性的疲劳失效。因此要特别注意选择兼容性优良的焊料和助焊剂,才能耐受住无铅再流焊时的高温冲击。
另外,各互连焊接部件均来自于不同生产厂商,因而部件质量难免参差不齐,如器件引脚可焊性不良等,对无铅工艺焊点可靠性有较大影响。比较典型的例子是.PCB板焊盘质量问题。由于以前的热风整平(HASL)焊盘涂层工艺存在一些缺点,因此目前OEM厂商应用较广泛的包括有机可焊性保护层(OSP)和Ni/Au涂层工艺。其中Ni/Au涂层又有浸金法和镀金法两种,浸金法由于工艺简单而较受国内厂商青睐,但此法难于控制Au层厚度,常会出现Au层厚度不足导致其下的Ni层氧化,影响回流焊接时焊点的性能。对于此种情况,厂商一般可用俄歇电子能谱仪(AES)精确测量PCB焊盘的Au层厚度是否符合规格。
(3)工艺:在SMT、MCM制作工艺过程中,通常会遇到诸如焊料储存温度不当、焊盘焊料不足、再流焊温度曲线设置不当等问题。就无铅焊接而言,再流焊工艺温度曲线的优化至为重要,优良的工艺既可保证形成高可靠性的焊接,又保持尽可能低的峰值温度。因此,目前除日本以外,其他国家的消费电子公司似乎都接受了锡银铜合金系列,合金中银所占比例为3.0%~4.7%,铜为0.5%-3.0%。不同成分的合金熔点相差不大,基本上在217℃-221℃之间,而锡铅合金(63%的锡和37%的铅)的液相温度是183℃,两者相差34℃。因此严密监控再流工艺中的关键变量,如峰值温度、高于液相温度的时间、浸渍时间、浸渍温度以及由于选择焊剂和焊膏而引起的斜坡速率,以确保再流焊过程保持1.33或高于1.33的Cpk。另外需注意的一点是含Bi无铅焊料的使用问题。研究发现,含Bi焊料与Sn-Pb涂层的器件接触时,回流焊后会生成Sn-Pb-Bi共晶合金,熔点只有99.6℃,极易导致焊接部位开裂的发生。因此对含Bi无铅焊料的使用需注意器件涂层是否为Sn-Pb涂层。
另外,关于无铅焊接工艺中出现的空洞问题。空洞是互连焊点在回流焊接中常见的一种缺陷,在BGA/CSP等器件上表现得尤为突出。由于空洞的大小、位置、所占比例以及测量方面的差异性较大,至今对空洞水平的安全性评估仍未统一。有经验的工程师习惯将无较大空洞(小尺寸的空洞体积之和不超过焊点体积的0.5%)、空洞比例低于15%~20%,且不集中于连接处的空洞归于回流焊接中常见的一种缺陷,并认为是可以接受的;另一方面,按照Motorola的研究结果认为直径3μm~5μm的空洞事实上能提高焊点的长期可靠性,因为它在一定程度上可以阻止焊点中裂纹的扩展。但一般认为大的空洞,或空洞面积达到一定比例后会给可靠性带来不利影响。
因此,在无铅焊接中,空洞仍然是一个必须关注的问题。在熔融状态下,Sn/Ag/Cu合金比Sn-Pb合金的表面张力更大,表面张力的增加势必会使气体在冷却阶段的外溢更加闲难,使得空洞比例增加。这一点在无铅锡膏的研发过程中得到证实,结果显示使用无铅锡膏的焊点中的空洞数量多于使用锡铅锡膏的焊点。大的空洞和一些小的球形空洞是由于助焊剂的挥发造成的,锡膏中助焊剂的配比是影响焊点空洞的最直接因素,因此无铅锡膏仍有很大的改善空间。作为新一代的无铅锡膏产品,Multicore(96SC 
来源:AnyTesting


