您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2025-07-11 21:33
先对比下传统正面供电和晶背供电芯片的结构差异。顾名思义,正面供电就是将电源通过正面顶层金属将电源输入通过金属过孔传递到晶体管;晶背供电是将电源通过背面金属直接传递到晶体管或通过M1金属层传递到晶体管。
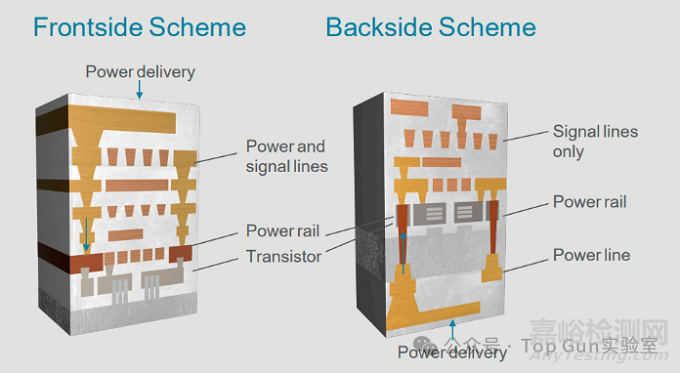
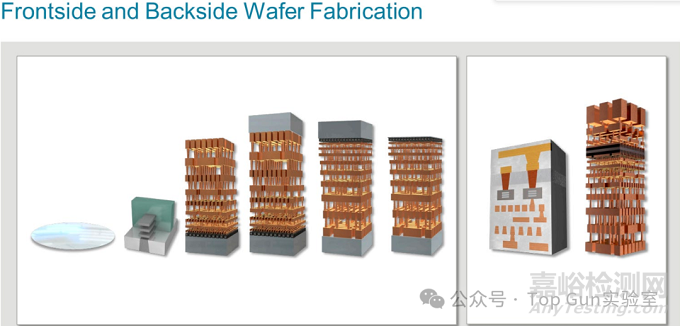
背面电源分配网络(Backside Power Delivery Network)是一种很巧妙的方法,它将信号层和电源层分开,更大程度地缩小晶体管的尺寸。下面是一个关于背面电源分配网络(BS-PDN)如何缩小结构尺寸的例子。
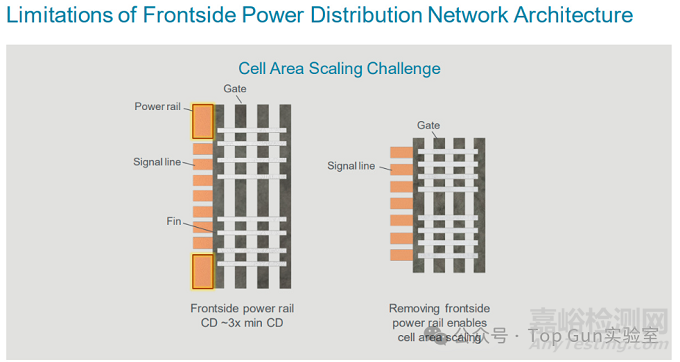
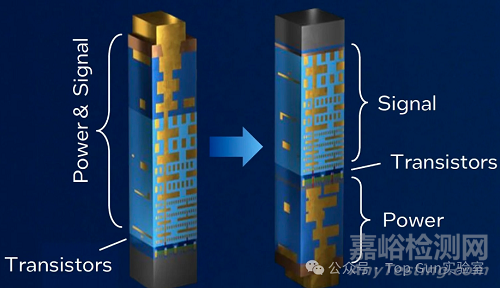
背面供电是一项巨大的变革。我们会把电源线移到衬底下方,这样就能在顶部腾出更多布线空间。要知道,现代芯片中有数十亿个相互连接的晶体管,芯片上有很多层信号互连线路。与此同时,芯片顶部还有一个电源网格,这是一个由电源线和地线组成的网络,它能在半导体芯片上分配电力,为晶体管供电。目前,所有的互连线路和电力传输都来自顶部的不同金属层。现在设想一下,当我们把所有电源都移到背面时,布线的复杂程度将会大大降低,我们就能更密集地布局和布线晶体管,改善拥塞状况。
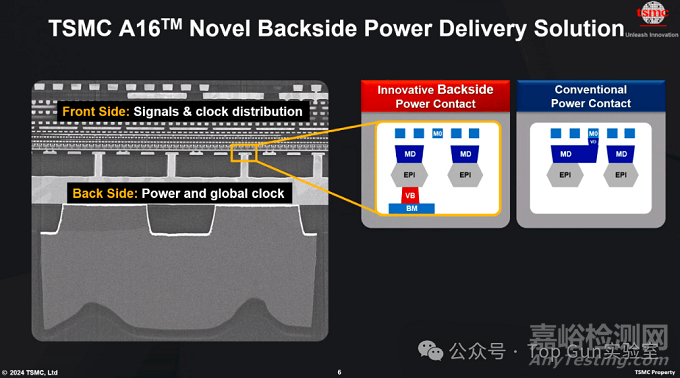
晶背供电技术的封装设计 从美国专利:US9331062可知,整个芯片安装在一个基板上,正面的第一套互连层通过键合焊盘(Wire Bond Pads) 连接到封装基板,背面的第二套互连层则通过焊球阵列(Solder Bumps) 连接到中介层然后再连接到基板上。
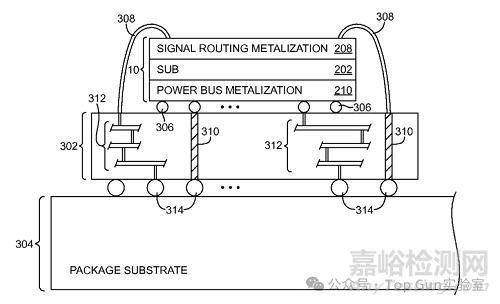
如上图所示
1、中介层(Interposer)-302包含两类关键结构:
1)硅通孔(TSV)结构-310
垂直贯穿中介层内部的硅核心层,提供机械支撑
材料:铜/钨/铝等导体
尺寸:直径1~10μm,长度10~100μm(与中介层厚度匹配)
功能:一端连微凸块(Microbump-306),另一端连C4焊球-314,用于向芯片-10供电;一端连接键合线-308,另一端连接C4焊球-314,用于传输用户数据与控制信号
2)互连布线路径-312
由多层金属走线和导电通孔构成
相比TSV:电阻更高,但布线更灵活(支持水平/垂直多向布线)
功能:连接键合线-308与焊球-314,传输用户信号;连接微凸块-306与焊球-314,传输电源信号。
2、芯片10简要图示描述说明(图片来源于IMEC)

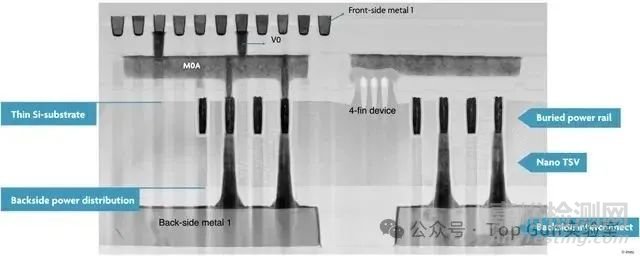
关键术语对照表
|
英文术语 |
中文工程术语 |
|
Interposer |
中介层 |
|
Through-Silicon Via (TSV) |
硅通孔 |
|
Microbump |
微凸块 |
|
C4 Bump |
C4焊球 |
|
Wire Bond |
键合线 |
|
2.5D Stacking |
2.5D堆叠 |
|
3D Stacking |
3D堆叠 |

来源:Top Gun 实验室


