您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2022-01-21 23:19
封装的缺陷和失效可能以多种物理形态表现出来,并且可能出现在封装的任何位置,包括外部封装、内部封装、芯片表面、芯片底面或者界面。为了对电子器件和封装进行有效的失效分析,必须遵循有序的、一步接一步的程序来进行,以确保不会丢失相关的信息。
设计、装配和制造等多种技术需要与其相适应的缺陷和失效分析技术。本部分将介绍用于密封微电子封装的各种缺陷和失效分析技术的基本信息,并重点介绍塑封缺陷和失效的相关技术。
1. 常见的缺陷和失效分析程序
封装失效分析技术大都可以分为两类:破坏性的和非破坏性的。非破坏检测技术,如目检、扫描声学显微技术(SAM)、X射线检测等等,不会影响到器件的各项性能,也不会改变和引入新的缺陷和失效。
破坏检测技术,如开封,会物理地、永久地改变封装,会改变已存在的缺陷或失效的证据。因此,缺陷与失效分析技术的使用顺序至关重要。非破坏性分析技术必须要在破坏性分析之前进行。在非破坏性检测之前,又常常需要通过电学测试。
① 电学测试
电学测试通常是在NDE之前进行,包括测量所有相关的电学参数,这些参数可能会暴露失效的模式,并可用于确定失效的部位。
电学测试包括探测芯片上、芯片与互连之间、芯片与电路板之间的短路、开路、参数漂移、电阻变化或其他不正常的电学行为。电学测试类型包括集成电路功能和参数测试、阻抗、连接性、表面电阻、接触电阻和电容等。
②非破坏性评价(NDE)
NDE的目的是在不破坏封装的前提下,识别并标记诸如裂缝、空洞、分层、引线变形、翘曲、褪色和软化这样的缺陷。
NDE的第一步是目检,直接用眼睛或光学显微镜观察都可以进行目检。
目检之后才是其他的非破坏性分析技术,如SAM、X射线显微技术和原子力显微技术(AFM)。SAM可以在不打开封装的情况下,识别塑封封装中的分层、空洞和芯片倾斜。X射线显微技术可以用来识别引线变形、空洞和芯片底座偏移等缺陷,但是可能会改变芯片的电学特性,所以一般都只在电学测试完成之后再进行。
对于封装翘曲等形变失效,可以用接触或者非接触的方法去测量。接触式的方法如AFM,非接触的方法如阴影云纹法。
封装的另外一种目视检测方法是染色渗透实验法(MIL-STD-883,方法1034):将整个封装在真空下浸入染色液中,然后再取出观察微裂纹、空洞和分层。
③ 破坏性物理分析
破坏性物理分析是会破坏部分或全部封装的密封微电子封装的缺陷和失效的分析方法。包括塑封密封料的分析测试、开封(塑料去除或者打开封装,Decapsulation)、用各种技术对封装内部进行检查以及选择性剥层。
通过硬度测试和红外(IR)光谱分析可以揭示塑封料的固化质量,DSC(扫描式量热仪)和等温DSC扫描同样也可用于测量其固化程度。
大多数的失效分析都需要开封来观察并定位塑料封装内部的缺陷。常用的Decapsulation方法包括化学方法(例如硫酸、硝酸腐蚀法)、热机械法和等离子刻蚀法。去除塑封料的化学试剂或溶剂取决于塑料的种类。一般来说,固化的环氧较难去除,需要用强酸;而硅树脂材料可以用氟化物溶剂来去除。
开封之后的内部检查可以用很多失效分析技术来进行。根据封装中失效的可能位置、预期失效点的大小和其他因素来选择这些技术。用于内部检查的失效分析技术包括光学显微技术、电子显微技术、红外显微技术和X射线荧光(XRF)光谱技术。
有些缺陷,如过电应力或者绝缘层上的针孔,都可能导致电路发生短路。它们可能位于表面下方而不可见,这就需要对半导体器件结构中不同成分的层分别进行去除。通常会采用湿法刻蚀或者干法刻蚀的方法。一般氧化层和金属化层采用湿法化学刻蚀来去除,氮化物钝化层采用氟基离子体或氩离子体进行刻蚀。
有很多技术可以进行失效定位。确定失效原理和失效机理要全面考虑失效位置、形态和经历以及封装制造和应用条件。
在某些情况下,像大裂纹、空洞或者引线键合断开这些失效都是非常明显的。然而在某些情况下,直接的失效证据被失效本身或者后续的分析手段毁坏了,这时需要通过模拟测试施加和实际失效逻辑性相关的环境条件或者电学负载手段,来再现已经观测到的失效。
2. 缺陷和失效分析手段
缺陷和失效分析的手段主要包括:光学显微技术、扫描声学显微技术、X射线显微技术、X射线荧光光谱显微技术、电子显微技术、原子力显微技术和红外显微技术。接下来将分别展开介绍。
①光学显微技术(OM)
光学显微技术是最便宜、方便、易于使用的分析检测手段,在不同等级封装的失效分析中都非常常用。由于芯片一般不透光,因此通常需要通过透镜来反射光线。
光学显微系统的主要参数包括物镜倍数、数字孔径、分辨率、景深和场曲率。光学显微技术主要包括亮场、暗场、相位对比、微分干涉相衬(DIC)、荧光显微技术和极化光线等。
网上关于明场和暗场的解释:
明场是靠吸收反射光的强度来确认物体的表面的,一般明场缺陷是暗的,背景是亮的。因为如果没有缺陷,入射光原路返回,所以是亮色的;如果有缺陷,光被散射了,这是接受到的光很弱,为暗色的。
暗场是靠光的散射原理来工作的,正常情况下入射光斜射到wafer表面,反射的光接收器是接收不到或者很暗,如果这里有缺陷,光会散射,这是接收器就会收到散射光,显示为亮色,所以暗场一般背景为暗,缺陷为亮。
② 扫描声学显微技术(SAM)
SAM技术是基于超声波在各种材料中的反射和传输特性而成像。通过SAM可以无损探测MC裂纹、芯片粘接分层、芯片倾斜和MC空洞等缺陷,它可以满足从生产批量筛选到实验室缺陷探测和失效分析的广泛需求。
SAM主要用两个显微镜来进行:扫描激光声学显微镜(SLAM)和C-模式扫描声学显微镜(C-SAM)。SAM的成像模式有很多种,其中实验室比较常用的是C模式和T模式(THRU-扫描)。
在定义塑封微电子中缺陷的确切状态时,C-SAM非常有用。C-SAM将一个非常短的声波脉冲引入样品中,在样品的表面和内部的某个界面反射形成反射波,声波返回时间是界面到换能器的距离和声波在样品中的速度的函数。电子门会在特定时间内“开启”,采集其某一深度界面的反射波而排除其它反射波。用选通的反射波信号亮度来调制一个与换能器位置同步的阴极射线管(CRT)。超声换能器在样品上方机械扫描,形成一幅声学图像。
在C模式中,聚焦的换能器在被关注的平面区域上扫描。透镜聚焦在某个深度,从那个深度产生的反射波被电学选通并显示,电子门的调整非宽即窄,图像包含的深度信息会与薄或厚的“片”相吻合。
例如,在塑封微电子中,窄门仅对芯片表面成像,较宽的门可同时对芯片表面、基板周边和引线框架进行成像。CRT上的灰度标尺图可以转换为幅度信息对比增强的伪彩色。
图像也可以用反射波极性或者相位信息进行颜色编码:从高声阻界面反射回来的正反射波以灰色表示,从低声阻界面反射回来的负反射波则用另一种颜色表示。声阻$Z$是与声波传播有关的材料特性,表示为:

其中,ρ是质量密度,Vsound是声波在材料中传播的速度。当声波入射到两种材料的边界时,部分波被反射,部分波被投射;如果界面存在分层,入射波就会被全反射。
③Hot spot 分析
Hot spot即热点分析,是电子工业常用的一种分析手段。一般包括EMMI、Obirch和Thermal三种模式。
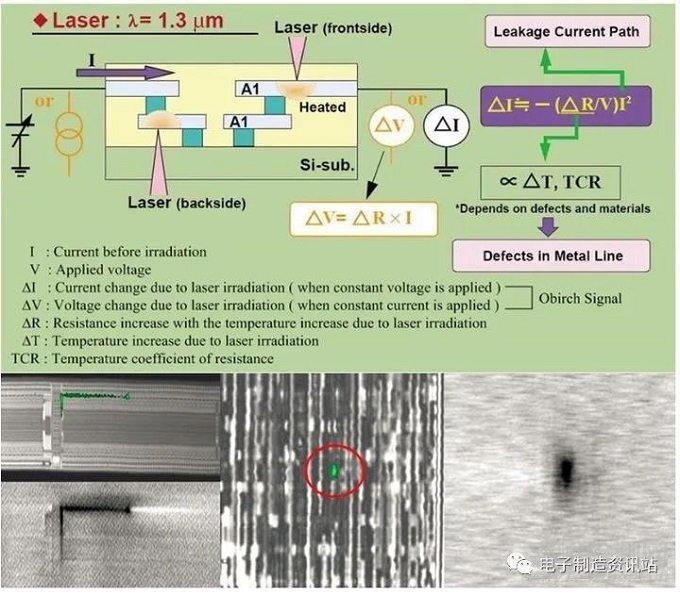
④其他测试手段
翘曲度测试
SEM/FIB
力学性能测试

来源:Internet


