您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2021-11-17 13:13
当今各种集成电路微电子器件(CPU,Flash、Memory、controller、Power等),都由大量的各种晶体管与电容、电阻、电感原件构成。随着集成电路器件的搞成集成、高速发展趋势,致使集成电路器件(die及die的半成品、Chip)在生产制造(wafer Fab,封装,测试)与使用(SMT为主)阶段对于受到静电的作用影响越发敏感。其中的绝缘介电质膜层(Gate oxide,passivation等)是静电损坏的主要结构,静电导致集成电路器件功能损坏的直接原因表现为绝缘膜层的漏电路过大。
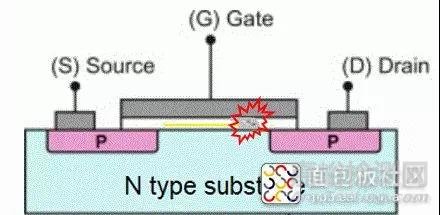
图1:静电导致晶体管Gate oxide膜层的击穿失效表征-漏电流过大
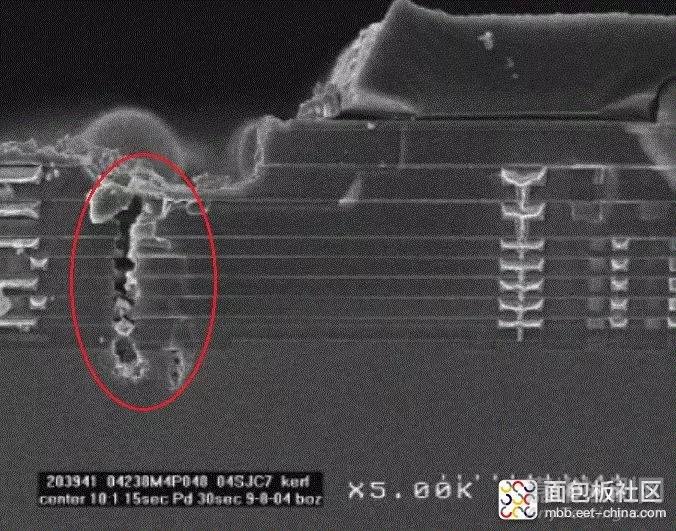
图2:集成电路制造后段wafer sawing工序的rinsing过程的静电导致绝缘膜层punch through的损坏情形
集成电路微电子器件制造中静电产生,主要来自取各制程设备操作与生产工序的相关过程,主要表现在:
1.物体间的接触-分离静电起电,如wafer在各种制程设备中wafer在ESC(Electro-Static Chuck)上的loading与lift up操作,又如PR(Photo Resist)coating过程中wafer的静电累积,再如wafer在spin drying过程中的静电起电与累积等;
2.真空制程设备中的RF plasma作用使wafer膜层上累积静电,CVD,PVD,DET;
3.高压rinsing过程wafer上的静电带电与静电累积等;
4.封装阶段wafer切割blue tape的贴膜与撕膜过程的静电在wafer上的产生与累积。
5.其他制程设备中的静电产生情形。

图3:wafer在ESC上的静电起电情形
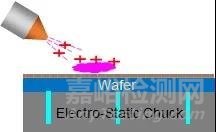
图4:wafer在高压rinsing过程中的静电带电情形
静电导致集成电路微电子器件发生功能不良(功能失效及电气可靠性下降),主要表现为wafer上方的静电累积过高导致绝缘膜层电性损坏(集中于wafer Fab阶段的制程设备与生产工序中),与静电放电(Electro-Static Discharge,ESD)过程产生的快速电流脉冲stress绝缘介质膜层引发击穿失效(主要发生于wafer的probing test,封装测试阶段的die bond、wire bond及各种电性测试工序)。
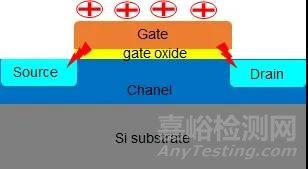
图5:wafer上方的静电累积导致die电性不良的情形
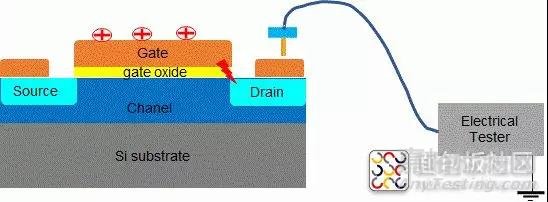
图6:Wafer/IC高静电带电后在电性测试工序发生ESD的电气失效情形

来源:Internet


